
|
Читайте также: |

где R - размер неоднородности,  - поглощательная способность неоднородности,
- поглощательная способность неоднородности,  - теплопроводность матрицы, T х - характерная для конкретного материала темп-pa. Так, например, для полупроводников, прозрачных в ИК-области спектра,
- теплопроводность матрицы, T х - характерная для конкретного материала темп-pa. Так, например, для полупроводников, прозрачных в ИК-области спектра,  , а Т* равна половине ширины запрещённой зоны, выраженной в градусах. Для диэлектриков, прозрачных в видимой области,
, а Т* равна половине ширины запрещённой зоны, выраженной в градусах. Для диэлектриков, прозрачных в видимой области,  и Т* - формальные параметры, описывающие температурный рост поглощения за счёт термического разложения материала. Разрушение материалов, содержащих поглощающие технологические дефекты микронных размеров, не связано со стадией тепловой неустойчивости, а обусловлено возникновением трещин за счёт термонапряжений в окрестности дефекта. ЛП таких материалов составляет 103-106 Вт/см2. Поскольку ЛП зависит от размера ПН, она перестаёт быть определенной величиной, если в среде содержатся ПН разного размера, и характеризуется вероятностью пробоя в данных условиях (рис.3.14). Для математического описания пробоя в этом случае используют статистические методы. ЛП элементов силовой оптики из металлов также ограничивается присутствием
и Т* - формальные параметры, описывающие температурный рост поглощения за счёт термического разложения материала. Разрушение материалов, содержащих поглощающие технологические дефекты микронных размеров, не связано со стадией тепловой неустойчивости, а обусловлено возникновением трещин за счёт термонапряжений в окрестности дефекта. ЛП таких материалов составляет 103-106 Вт/см2. Поскольку ЛП зависит от размера ПН, она перестаёт быть определенной величиной, если в среде содержатся ПН разного размера, и характеризуется вероятностью пробоя в данных условиях (рис.3.14). Для математического описания пробоя в этом случае используют статистические методы. ЛП элементов силовой оптики из металлов также ограничивается присутствием
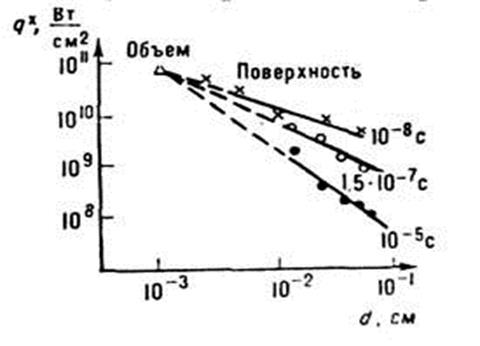
Рис.3.13. Изменение порога пробоя поверхности стекла К8 в зависимости от размеров облучаемого пятна d при трёх длительностях импульса неодимового лазера.
С наличием неоднородности часто связано возбуждение поверхностных электромагнитных волн и локализованных плазмонов, вследствие чего падает коэффициент отражения металла и резко возрастает скорость нагрева поверхности.
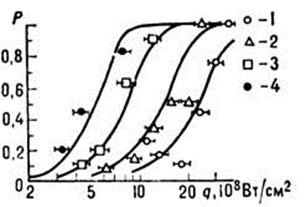
Рис.3.14. Вероятность оптического пробоя поверхности стекла К8 в зависимости от плотности светового потока при различных площадях пятен S: 1 - S=l,8 мм2; 2 - 7,3 мм2; 3 - 30 мм2; 4 - 120 (130) мм2.
3.6.2 Контроль лучевой прочности оптических элементов
Развитие квантовой электроники (разработка и эксплуатация мощных импульсных лазеров) и оптико- локационных систем выдвинуло на передний план проблему лучевой прочности оптических элементов лазерных систем и, в первую очередь, диэлектрических зеркал резонаторов лазера. Именно разрушение этих элементов под действием собственного излучения лазера ограничивает их предельную мощность, стабильность, срок службы и является одной из основных причин, препятствующих созданию мощных и экономичных лазерных систем.
При сильном воздействии лазерного излучения на прозрачные диэлектрики происходят поглощение и аккумуляция энергии, преобразование ее в другие виды (тепловую, механическую и др.) и при превышении интенсивности излучения некоторой пороговой величины – динамическое развитие микро-, а затем и макроразрушений. Проявление этих разрушений в зависимости от свойств материала и параметров лазерного воздействия будет различным. Для объема оптических материалов характерны точечные повреждения, звездообразное растрескивание, образование протяженных треков. Значительно легче, из-за большой дефектности, разрушается поверхность оптических деталей. Входная поверхность оплавляется, растрескивается, испытывает тепловой ожог. Разрушение выходной поверхности носит «взрывной» характер, сопровождается выкалыванием части материала и образованием глубоких трещин, радиально расходящихся от области повреждения.
Диэлектрическое покрытие на стеклянной подложке представляет сложную, часто многослойную, систему чередующихся пленок из многокомпонентных веществ, имеющих аморфную или кристаллическую структуру. Естественно, что такая система будет обладать пониженными термомеханическими характеристиками и еще больше увеличивать дефектность границы раздела, тем самым, определяя максимальную интенсивность излучения, проходящего через элементы силовой оптики. Оптические покрытия имеют и иную морфологию разрушения; вспучивание отдельных участков в облучаемой зоне, отслоение, растрескивание, послойное разрушение.
Металлические пленки на стекле под действием лазерного импульса плавятся, испаряются, скатываются к краям облучаемой зоны.
Порог разрушения оптических материалов зависит от множества факторов, определяемых свойствами этих материалов, а также от режима работы лазера: длительности импульса, размера облучаемой зоны, распределения энергии по сечению пучка, длины волны генерации и т.д. Поэтому, при контроле лучевой прочности оптических материалов, помимо критерия разрушения и величины порога разрушения, необходимо также указывать экспериментальные условия, при которых измерялся порог разрушения. Основными факторами, влияющими на порог разрушения многослойных диэлектрических систем, являются начальное поглощение и усугубляющее его рассеяние света в системе, т.е. те общие энергетические потери излучения, которые приводят к «запуску» того или иного механизма разрушения. В настоящее время общепризнанным механизмом разрушения (по крайней мере, в микро - миллисекундном диапазоне длительности лазерного воздействия) является механизм, обусловленный поглощением энергии лазерного излучения слоями с последующим тепловым разрушением системы.
Под лучевой (световой) прочностью понимают пороговую плотность мощности или энергии лазерного излучения, при которой происходит изменение оптических свойств детали, и появляются видимые разрушения на ее поверхности.
Для количественной характеристики величины порога лазерного разрушения обычно используют пороговые или средние значения плотности энергии (мощности) при определенном выборе критерия разрушения и измерении параметров светового импульса, приводящего к разрушению. На практике в качестве критерия разрушения чаще всего выбирают появление яркой вспышки у поверхности образца, связанной с возникновением плазмы, так как это почти всегда соответствует наличию повреждений, видимых невооруженным глазом или в микроскоп. Пороговая плотность энергии НР и мощности ЕР разрушения определяется выражениями:

где Wn – пороговая энергия (часть энергии импульса, выделившаяся к моменту разрушения), Дж; Sэкв. – эквивалентная площадь воздействия, т.е. площадь эквивалентного светового пятна с равномерным распределением освещенности, равным максимальной освещенности в реальном пятне, см 2; tв – время воздействия, т.е. время от начала импульса до момента разрушения, с
Средняя плотность энергии и мощности:

где Wn – пороговая энергия лазерного импульса, Дж; t0.5 – полуширина лазерного импульса, т.е. его длительность на уровне 0,5 максимального значения мощности, c. Мощное излучение, создаваемое лазером 1 (лазера на рубине или стекле с неодимом), работающем в режиме свободной генерации или модулированной добротности (при введенном модуляторе 2), направляется призмой 7 на линзу 9, в фокальной плоскости которой установлена контролируемая поверхность образца 10 (рис.3.15). Фокусным расстоянием линзы, качеством ее изготовления и расходимостью лазерного излучения определяется площадь облучения контролируемой поверхности. Часть энергии излучения параллельной стеклянной пластинкой 8 и линзой 14 направляется на измеритель энергии лазерного излучения 15 (ИМО-2Н).

Рис.3.15. Блок схема установки для испытания оптического стекла и оптических покрытий на лучевую прочность.
Дискретное изменение лазерной энергии до величины порога разрушения поверхности образца осуществляется набором калиброванных нейтральных светофильтров 6 на турели, установленной у выходного зеркала лазера.
Форма лазерного импульса контролируется при помощи фотоприемника 20 и запоминающего осциллографа 21.
Для наблюдения за появлением на поверхности покрытия используется микроскоп с телекамерой 12, установленный за образцом. Зона воздействия наблюдается на мониторе 13 увеличением 200х. Защита микрообъектива микроскопа во время воздействия лазерного импульса на образец осуществляется экраном 11. Подсветку зоны воздействия для надежной работы телекамеры обеспечивает осветитель 18, 19. Для создания более равномерного распределения энергии по сечению пучка между задним зеркалом 5 лазера и активным телом устанавливается диафрагма 3 и длиннофокусная линза 4.
Для облегчения юстировки измерительной установки и визуализации зоны воздействия за задним зеркалом облучающего лазера устанавливается гелий-неоновый лазер ЛГ-66.
Юстировочными приспособлениями лазера ЛГ-66 добиваются того, чтобы его луч проходил через центры диафрагм, установленных на торцы активного элемента и попадал на образец. Юстировка облучающего лазера осуществляется с помощью автоколлиматора 16.
После этого производится облучение фотобумаги, установленной в плоскости образца. При качественно выполненной юстировке зона разрушения на бумаге должна совпадать с пятном от лазера ЛГ-66.
Дальнейшая юстировка всех элементов схемы производится по лучу лазера. Образец в оправе устанавливается так, чтобы его поверхность была перпендикулярна оптической оси, и луч лазера проходил через центр образца.
4 МЕТОДЫ ЭЛЕКТРОННОЙ СПЕКТРОСКОПИИ
4.1. Электронная спектроскопия состояния поверхности
С помощью спектроскопических методов получают сведения о химическом составе, структуре поверхности, и распределении заполненных и незаполненных энергетических поверхностных уровней, степени окисления поверхностных молекул и химической активности поверхности или молекул, расположенных на поверхности, о характеристике связей системы твердое тело– адсорбат.
Глубина анализа обычно определяется тем сортом частиц, которые используются в конкретном эксперименте, и меняется от десятых долей нанометра до103 нм.
Существует множество методов, которые можно отнести к классу спектроскопических. Представление об этом дает «диаграмма Пропста», представленная на рис. 4.1
Стрелки на этой диаграмме, направленные к твердому телу, соответствуют первичным частицам. Стрелки, направленные наружу, соответствуют вторичным частицам, по которым можно судить о состоянии твердого тела. Каждому сочетанию падающей и отраженной частицы соответствует экспериментальный метод. Таких сочетаний 36. Однако число возможных экспериментальных методов значительно больше, т.к. каждому данному сочетанию стрелки, направленной внутрь, со стрелкой, направленной наружу, могут соответствовать несколько спектрометрических методов в зависимости от того, какие свойства падающих и вылетающих частиц исследуются.
Широкое распространение в настоящее время получила электронная спектроскопия, основанная на анализе электронов, рассеянных или эмитированных поверхностью твердого тела.

Рис.4.1 Диаграмма Пропста
Электронная спектроскопия лишь сравнительно недавно нашла применение для исследования поверхностей твердых тел, хотя электронно-спектроскопические исследования молекул газов весьма активно проводятся в течении последних десятков лет.
В электронной спектроскопии реализуется три основных подхода:
1) применение рентгеновских лучей для возбуждения электронов внутренних оболочек, или метод рентгеновской фотоэлектронной спектроскопии (РФС); 2) использование более мягкого ультрафиолетового излучения, позволяющего исследовать валентные уровни, или ультрафиолетовая электронная спектроскопия (УФС); 3) исследование оже-электронов или электронная ожеспектрскопия (ЭОС). Процессы, характерные для электронной спектроскопии, можно проиллюстрировать спомощью схем, представленных на рис.4.2. При облучении поверхности фотонами баланс энергии в упрощенном виде может быть записан следующим образом: Eкин = hν −εсв , (4.1)
где Eкин-кинетическая энергия электронов, испускаемых из молекулы под
действием фотона с энергией hν, εсв–энергия связи электрона.
Зная энергию первичного излучения hν и определяя экспериментально кинетическую энергию эмитированных электронов Eкин , можно найти энергию связи данного атома или молекулы с поверхностью. Принципиальная схема электронного спектрометра представлена на рис.4.3
Спектроскопические методы можно условно разделить на группы: методы исследования структурных и энергетических характеристик поверхности, методы анализа химического состава поверхности и методы исследования кинетики поверхностных реакций. Методы исследования структурных и энергетических характеристик поверхности основаны на процессах характерных для электронной спектроскопии, которые показаны на рис 4.2

Рис.4.2 Процессы, характерные для электронной спектроскопии:
а) УФС; б) РФС; в) рентгеновская флуоресценция; г) оже-процесс
 |
Рис. 4.3 Принципиальная схема спектрометра
4.2. Ультрафиолетовая фотоэлектронная спектроскопия (УФС).
В этом методе на поверхность падает ультрафиолетовое излучение, и исследуются эмитированные фотоэлектроны. Основной переменной является длина волны ультрафиолетового излучения, две другие переменные – угол падения и поляризация света. В процессе измерений регистрируется энергетический спектр эмитированных фотоэлектронов, а в некоторых экспериментах также их угловое распределение. Для появления фотоэлектронов должна быть обеспечена возможность электронного перехода с некоторого заполненного энергетического уровня на уровень, находящийся выше уровня свободного электрона (рис. 4.2а). при этом измеренное распределение фотоэлектронов по энергиям отражает плотность заполненных энергетических уровней как объемных, так и поверхностных.
Метод УФС применяется при исследовании поверхностных состояний, связанных с взаимодействием в системе адсорбат – твердое тело, и позволяет получить ценную информацию о хемосорбции. Важным преимуществом метода является малое возмущение поверхности (практически неразрушающий метод диагностики).Приблизительная глубина составляет 5 нм. Метод является одним из наиболее старых методов диагностики поверхности.
Обычно при получении спектров УФЭС используется газоразрядный гелиевый источник линейчатого спектра, который может работать в двух режимах: либо в режиме, обеспечивающем максимальный, выход излучения Hel (21,2 эВ), либо в режиме, обеспечивающем максимум выхода излучения Hell (40;8 ЭВ), хотя могут быть использованы и другие инертные газы (обычно излучающие при несколько меньших энергиях), а в последнее время прилагается много усилий для использования непрерывно перестраиваемого монохроматического синхротронного излучения. Использования таких низких энергий фотонов (менее 40 эВ и обычно 21,2эВ), несомненно, позволяет исследовать лишь валентные уровни. Эти состояния включают заполненные состояния валентной зоны чистых поверхностей твердого тела, а также состояния связывающих орбиталей адсорбированных молекул. УФЭС чувствует поверхность, но не всегда так же поверхностно чувствительна, как другие методы анализа поверхности. В значительной степени эти два различных взгляда на УФЭС привели к двум относительно разделенным областям применения этого метода. Первая область связана с исследованием поверхностной электронной структуры, а именно структуры электронных зон чистых поверхностей и упорядоченных слоев адсорбированных на них атомов. Это направление работ вытекает непосредственно из более раннего интереса к исследованию зонной структуры объемного твердого тела с помощью фотоэмиссии. |Вторая область касается главным образом идентификации молекулярных образований на поверхности и здесь УФЭС может быть использована для характеристики процесса их распада или происходящих с ними реакций, а также для идентификации характеристических электронных энергий, относящихся к связям внутри молекул.
Потенциальные возможности УФЭС при исследовании адсорбированных на поверхности молекул могут быть наиболее эффективно проиллюстрированы одним или двумя примерами. На рисунке 4.4 представлены спектры УФЭС, полученные без углового разрешения с использованием падающего неполяризованного излучения Hel (hv – 21,2 эВ). Рисунок 4.4, г представляет спектр фотоэмиссии от молекул газообразного бензола (С6H6): шкала энергий дана в единицах потенциала ионизации соответствующего начального состояния по отношению к уровню вакуума. Видно, что этот спектр состоит из серии полос, которые при более высоком энергетическом разрешении детектора оказываются состоящими из множества тонких линий, соответствующих возбужденным колебательным состояниям. Каждая полоса соответствует определенному начальному электронному состоянию или молекулярному орбитальному состоянию молекулы (или случайному перекрытию двух таких полос).
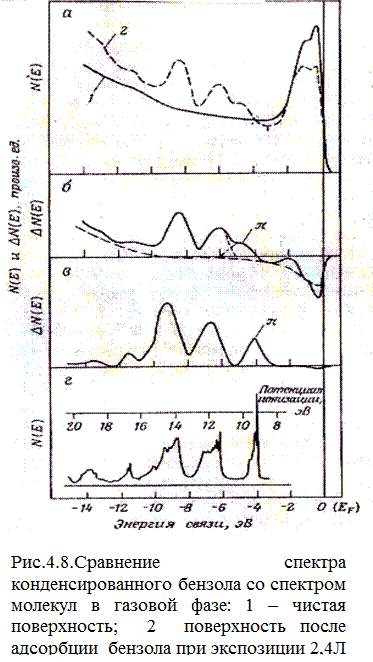 На рис. 4.4, а сплошной линией показан спектр УФЭС чистой поверхностиNi {111}, а штриховой фотоэмиссионный спектр после экспозиции, равной 2,4люкс, этой поверхности в парах бензола при 300 К.
На рис. 4.4, а сплошной линией показан спектр УФЭС чистой поверхностиNi {111}, а штриховой фотоэмиссионный спектр после экспозиции, равной 2,4люкс, этой поверхности в парах бензола при 300 К.
На рис 4.4, б представлен разностный спектр, полученный как разность этих двух спектров, в то время как на рис. 4.4, в приведен еще один разностный спектр, полученный при вычитании спектра чистой поверхности из спектра системы, в которой бензол конденсировался на поверхность при 150 К и давлении насыщенных паров бензола 2·10-7мм рт.ст.; г – УФЭС – спектр бензола в газовой фазе, смещенный относительно верхних спектров для сопоставления относительного расположения пиков
Сравнение спектра конденсированного бензола со спектром молекул в газовой фазе показывает, что, кроме некоторого уширения и сглаживания, структура этих спектра одна и та же.
4.3 Широкополосные электронные спектрометры
Основным назначением любого электронного спектрометра является выделение из электронов, входящих в спектрометр с широким набором энергий (и углов: вследствие расходимости источника), только тех, энергии которых заключены в определенной узкой области (независимо от угла входа). В идеальном случае этого можно, достичь при использовании некоторых типов энергетических фильтров с высоким заданным энергетическим разрешением, но можно получить и с помощью более простого анализатора с последующей обработкой выходного сигнала. При исследовании поверхности в качестве широкополосного светосильного фильтра наиболее широко используется анализатор с задерживающим полем (АЗП) рис.4.5.
На рисунке 4.5 приведена электронно-оптическая схема, используемая для ДМЭ. Ее можно рассматривать как наиболее часто встречающуюся в случае АЗП, применяемой при исследовании поверх  ностиДействительно, тот факт, что электронная оптика ДМЭ (уже использующаяся многими исследователями, работающими в этой области) очень хорошо подходит для применения в качесве АЗП,
ностиДействительно, тот факт, что электронная оптика ДМЭ (уже использующаяся многими исследователями, работающими в этой области) очень хорошо подходит для применения в качесве АЗП,  объясняет популярность этого анализатора.
объясняет популярность этого анализатора.
. Действительно, тот факт, что электронная оптика ДМЭ (уже использующаяся многими исследователями, работающими в этой области) очень хорошо подходит для применения в качесве АЗП, 
 объясняет популярность этого анализатора. Образец умещается в центр набора концентрических сферических секторных сеток. Первая сетка, ближайшая к образцу, как и в экспериментах по ДМЭ, находится под тем же потенциалом (земля), что и образец; это гарантирует распространение электронов, покидающих образец, в направлении сетки в свободном от поля пространстве и обеспечивает таким образом радиальную геометрию эксперимента. В эксперименте по ДМЭ следующая сетка находится под потенциалом, несколько меньшим, чем потенциал катода электронной пушки, так что все электроны, имеющие энергию, меньшую, чем энергия падающих на образец электронов, тормозятся и не проходят через последнюю стадию ускорения на пути к люминесцентному экрану. Таким образом, в обычном эксперименте по ДМЭ сетки используются в качестве светосильного анализатора, пропускающего только упруго рассеянные электроны.
объясняет популярность этого анализатора. Образец умещается в центр набора концентрических сферических секторных сеток. Первая сетка, ближайшая к образцу, как и в экспериментах по ДМЭ, находится под тем же потенциалом (земля), что и образец; это гарантирует распространение электронов, покидающих образец, в направлении сетки в свободном от поля пространстве и обеспечивает таким образом радиальную геометрию эксперимента. В эксперименте по ДМЭ следующая сетка находится под потенциалом, несколько меньшим, чем потенциал катода электронной пушки, так что все электроны, имеющие энергию, меньшую, чем энергия падающих на образец электронов, тормозятся и не проходят через последнюю стадию ускорения на пути к люминесцентному экрану. Таким образом, в обычном эксперименте по ДМЭ сетки используются в качестве светосильного анализатора, пропускающего только упруго рассеянные электроны.
Однако если тормозящие сетки находятся под несколько более низким потенциалом то все электроны, имеющие энергию, большую, чем энергия, соответствующая этому потенциалу, попадают на люминесцентный экран (который в этом случае используется просто как коллектор тока). Таким образом, если распределение электронов по энергии описывается функцией N(Е), а тормозящий Потенциал равен V0 и соответствует минимальному значению энергии пропускания Е0 = eV0, то ток, поступающий на коллектор, равен  или, поскольку максимальная энергия эмитируемых образцом электронов соответствует энергии электронов в первичном пучке Ер, ток в действительности равен
или, поскольку максимальная энергия эмитируемых образцом электронов соответствует энергии электронов в первичном пучке Ер, ток в действительности равен  . Очевидно, что если этот ток продифференцировать, то результат будет представлять собой искомое распределение электронов по энергии N(Е). Для этого проще всего промодулировать тормозящий потенциал V
. Очевидно, что если этот ток продифференцировать, то результат будет представлять собой искомое распределение электронов по энергии N(Е). Для этого проще всего промодулировать тормозящий потенциал V
4.4 Диагностика поверхности методом дифракции электронов.
Под дифракцией в оптике понимается явление огибания препятствий световой волной. При этом в процессе частицы испытывающие дифракцию, несут информацию о структуре препятствия. Аналогичные явления можно наблюдать (с применением более чувствительной аппаратуры) для электронных волн и рентгеновских лучей. Данный метод дает информацию о структуре поверхности твердого тела и структуре адсорбата.
Для исследования объектов очень малого размера необходимо использовать коротковолновые излучения, а для объектов атомных размеров (несколько десятков долей нанометров) можно использовать только рентгеновские лучи и электроны. Действительно, рентгеновское излучение, например, соответствующее Kα -линии меди, имеет длину волны λ=0,154 нм, а электрон в зависимости от энергии имеет длину волны
λ(нм) =1,5 /V)  12,, (4.2)
12,, (4.2)
где V –разность потенциалов в вольтах.
Если V =20 В, то λ≈0,27 нм, а если V =100 кэВ, то λ≈0,004 нм. Однако при использовании таких излучений возникает трудность создания подходящих линз. Для рентгеновских лучей создание таких линз вообще невозможно. Электроны, как известно, можно фокусировать с помощью электрических и магнитных полей. Быстрые электроны проникают вглубь твердого тела на значительную глубину. Так, например, в просвечивающем микроскопе, в котором используются электроны с энергией 100 кэВ, можно исследовать твердые тела толщиной 100 нм. Однако при этом поверхностные атомы, дающие информацию о структуре поверхности, вносят лишь малый вклад в общую картину. Поэтому для исследования структуры поверхности используют два подхода. Первый – это дифракция отраженных быстрых электронов с энергией 30 – 50 кэВ. Поскольку в этом методе электроны падают на твердое тело под углом скольжения, они рассеиваются преимущественно в поверхностном слое. Второй подход – дифракция медленных электронов (ДМЭ). Энергия электронов в этом методе лежит в интервале 10 – 300 эВ. Амплитуда рассеяния таких электронов атомами твердого тела велика. Поэтому даже при нормальном падении эти медленные электроны полностью рассеиваются в нескольких первых атомных слоях вблизи поверхности.
Для наблюдения дифракции медленных электронов можно использовать схему представленную на рис. 4.5. Электронная пушка эмитирует на поверхность первичные электроны с энергией 10 – 300 эВ и длиной волны 0,388 – 0,071 нм. Сила тока в электронном пучке луча составляет ~ 1 –2 мкА, а диаметр пучка ~ 1 мм. Плотность тока при этом оказывается достаточно большой, чтобы вызвать изменения в адсорбированных поверхностных слоях, и это необходимо учитывать при интерпретации экспериментальных данных.
Для детектирования рассеянных электронов используется либо цилиндр Фарадея, либо флуоресцентный экран, на котором наблюдается и фотографируется вся дифракционная картина одновременно.
ДМЭ позволяет получить данные о периоде кристаллической решетки. Поскольку используются очень медленные электроны, которые не проникают глубоко в твердое тело, полученная информация относится главным образом к одному или двум верхним слоям поверхностных атомов.
ДМЭ используется:
а) при очистке поверхности для качественного наблюдения за устранением остаточных слоев чужеродных атомов (критерием служит появление достаточно четкой структуры, связанной с кристаллической решеткой основного материала);
б) для получения данных о реконструкции поверхности;
в) для получения информации о порядке величины расстояний между адсорбированными частицами;
г) для получения информации о регулярных ступеньках на поверхности (например, вследствие разрезания образца).
ДМЭ можно также использовать для определения амплитуды колебаний поверхностных атомов чистого кристалла по размытию дифракционных пятен.
Качественная интерпретация дифракционной картины достаточно проста. Однако полное описание процессов дифракции представляет собой чрезвычайно сложную проблему, которая требует рассмотрения взаимодействия поля падающей волны со всей дифракционной решеткой.
4.5. Рентгеновская фотоэлектронная спектроскопия
При облучении поверхности вещества фотонами могут протекать различные процессы, в том числе образование фотоэлектронов, рассеяние фотонов, фотодесорбция атомов и молекул с поверхности (рис. 4.6).

Рис.4.6 Процессы на поверхности при облучении фотонами
Рентгеновская фотоэлектронная спектроскопия является методом поверхностного анализа, использующийся для определения химического состава твердых поверхностей. Позволяет определять энергию связи. Анализ основан на определении энергии электронов, испускаемых твердым телом в результате подвергания его монохроматическому рентгеновскому излучению. Очень эффективен для обнаружения на поверхности кремния закисей кремния. Облучение поверхности образцарентгеновским пучком способно в случае высоких энергий рентгеновских квантов вызвать эмиссию вторичных электронов за счет возбуждения внутренних электронных оболочек атомов. Электроны с различными энергиями связи обусловливают появление раздельных пиков фотоэлектронного спектра. Применение этого явления для химического анализа облучаемой поверхности получило название электронной спектроскопии для химического анализа. Первичный рентгеновский пучок обычно возбуждается за счет облучения электронами низких энергий анода из алюминия или магния. Так как энергия вторичных фотоэлектронов, возбуждаемых при использовании алюминиевых и магниевых источников, достаточно низкая, то глубина проникновения вторичных электронов в исследуемое вещество менее 5 нм. Поэтому появляется возможность анализировать химический состав тонкого (несколько атомных слоев) приповерхностного слоя. Для исследования профилей распределения примесей по глубине осуществляется ионное распыление поверхностных слоев. Разрешение по глубинерентгеновской фотоэлектронной спектроскопии очень высокое и не превышает толщины атомного монослоя. Разрешение по площади (в плоскости) очень низкое, так как диаметр первичного рентгеновского пучка составляет 1-2 мм.
Возможности метода рентгеновской фотоэлектронной спектроскопии следующие. Во-первых, метод обеспечивает возможности исследования радиационно-нестойких материалов, так как процессы диссоциации и десорбции при возбуждении рентгеновскими квантами существенно меньше, чем, например, при электронном возбуждении. Во-вторых, использование электрически нейтрального первичного пучка значительно снижает вероятность заряда поверхности исследуемых диэлектриков. В-третьих, по данным рентгеновской фотоэлектронной спектроскопии можно получать информацию о химической связи. Энергетические уровни электронов внутренних оболочек зависят от валентного состояния и типа химической связи. Типичное энергетическое разрешение пиков спектров рентгеновской фотоэлектронной спектроскопии составляет ~ 0,5 эВ. Поскольку различные типы химической связи часто обусловливают сдвиги энергии связи на большие величины, то эти сдвиги можно детектировать в целях идентификации характера связи. Общий принцип фотоэлектронной спектроскопии показан на рис. 4.7. Суть метода РФС состоит в получении фотоэлектронных спектров, т.е. измерении кинетической энергии внутреннего или валентного электрона, выбитого квантом известной энергии электромагнитного излучения.
Дата добавления: 2015-07-10; просмотров: 226 | Нарушение авторских прав