
|
Читайте также: |
Монтаж методом «flip-chip» применяют для кристаллов со столбиковыми выводами. Кристаллы монтируют на основание корпусов или подложки планарной стороной. При этом рисунок их контактных площадок является зеркальным отображением расположения выводов (рисунка) на кристалле.
Последовательность выполнения монтажа кристалла со столбиковыми выводами из низкотемпературного припоя на подложку показано на рис. 5.
Используется способ монтажа полупроводникового кристалла на основание корпуса (подложку), имеющего углубление или сквозное отверстие, вокруг которого располагаются контакты и проводники [34]. Форма канавки, включая зазор между кристаллом и основанием корпуса, а также пазы по углам обеспечивает в процессе герметизации пластмассой затекание жидкого компаунда под кристалл и защиту лицевой поверхности кристалла. При наличии сквозного отверстия на обратную поверхность корпуса накладывают пластину, чтобы не допустить излишний расход компаунда.
На паяемых поверхностях кристалла и подложки формируют контактные столбики. При сборке между кристаллом и подложкой размещают фольгу толщиной менее 50 мкм из диэлектрических материалов: Al 2O3, полиимида или оксида бериллия [35]. В фольге имеются отверстия, расположение которых соответствует расположению контактных столбиков на поверхностях соединяемых деталей. При сборке в отверстиях фольги размещают припой, совмещают отверстия со столбиками кристалла и подложки и нагревают прибор до температуры плавления припоя. Использование диэлектрической фольги устраняет растекание припоя по поверхности подложки и уменьшает вероятность короткого замыкания между контактами прибора.
С целью повышения качества монтажа приборов со столбиковыми выводами в качестве защитного диэлектрического покрытия на планарную поверхность полупроводниковых пластин наносят полимерный лак, толщина которого находится в пределах от 8 мкм до 2/3 высоты выводов [36].
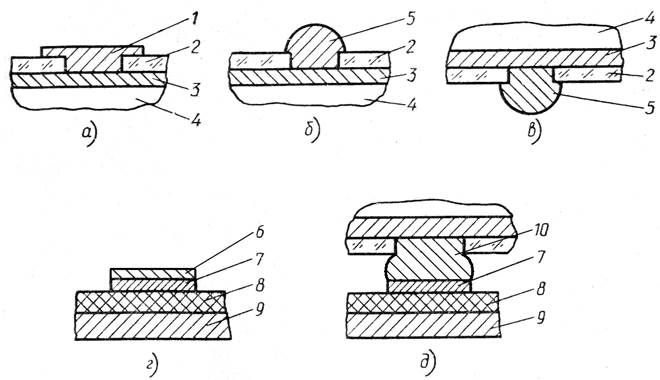
Рис. 5. Последовательность выполнения монтажа кристалла со столбиковыми выводами из низкотемпературного припоя на подложку: а, б – гальваническое нанесение припоя на кристалл и оплавление его, в – переворачивание кристалла, г – нанесение припоя на подложку, д – соединение кристалла с подложкой; 1 – припой, 2 – пленка оксида кремния, 3 – слой металлизации на кристалле, 4 – кристалл, 5, 6 – оплавленный припой на кристалле и подложке, 7 – контактная площадка, 8 – подложка, 9 – основание корпуса, 10 – столбик припоя
Пайка кристаллов со столбиковыми выводами на контактные площадки тестовой керамической подложки, которая позволяет также демонтировать кристаллы и повторно использовать подложку для испытаний и контроля электропараметров других ИС, осуществляется по разработанному способу [37]. Столбики на кристалле представляют собой слои из сплава Cr:Cu/Cu/Au или Sn. Верхний слой контактов подложки состоит из W или Ta. В качестве припоя применяется сплав 95 % Pb-Sn, осаждаемый или наплавляемый на столбик. Соединение кристаллов с тест-подложкой проводится их совмещением и нагревом до 342 °С с последующей выдержкой при температуре 250 °С в специальной камере. В процессе напайки кристаллов в камеру подается формир-газ, или небольшое количество паров муравьиной кислоты, или CO. Демонтаж кристаллов проводится погружением нагретой до 340 °С подложки в смесь полиэтиленгликоля с канифолью.
На кристалле формируют контактные выступы из Au с покрытием припоем из In-Sn [38]. Монтаж кристалла выполняют с нагревом до температуры, не превышающей температуру плавления припоя. Затем в зазор между кристаллом и подложкой вводят раствор термопласта и проводят термообработку для обеспечения надежного механического соединения кристалла с подложкой.
Специалисты французского центра ядерных исследований разработали сверхминиатюрный процесс перевернутого монтажа полупроводниковых кристаллов на поверхность подложки [39]. В данной технологии используются шарики припоя диаметром 0,01 мм, что позволяет уменьшить расстояние между контактами до 50 мкм. Процесс сборки применяется при наличии на поверхности подложки двух уровневой системы металлизации, что позволяет использовать кристаллы, содержащие до 3000 контактных площадок.
Для контроля положения столбиковых выводов в процессе монтажа методом «flip-chip» [40] структуру на подложке освещают от двух независимых источников наклонными лучами. Положение определяют, контролируя ориентацию теней от выводов на поверхности подложки относительно направления падения света.
В статье [41] приведены результаты исследований шести составов припоя, а также токопроводящего адгезива с серебряным наполнителем, которые используются при изготовлении СБИС в корпусах с матрицей шариковых выводов с кристаллами, монтируемыми на основание корпуса. Паяные соединения исследовались с помощью микрошлифов, а также подвергались испытаниям на прочность при термоциклировании от минус 55 до 125 °С. Установлено, что соединения с припоем Sn/Bi способны выдерживать свыше 750 термоциклов, с припоем Sn/Ag/Bi – свыше 620, с припоем Sn/Pb – 225. Растрескивание соединений на основе токопроводящего адгезива происходит после 260 термоциклов только на участках, где имеются поры в адгезиве.
Для отвода тепла от кристалла СБИС, смонтированного на подложку методом «flip-chip», используется пластинчатый теплоотвод, который крепится на кристалл сверху пайкой. Теплоотвод изготавливают из материала на основе углерода с ТКЛР равным (6 – 10)×10-6 °С-1 [42]. Теплоотвод может быть изготовлен, например, из пористого графита, пропитываемого полимером, или в виде углеполимерного композита с волокнами углерода. Надежность сборки обеспечивается благодаря согласованности кристалла с теплоотводом по ТКЛР.
Литература
1. Способ получения жидкого припоя в виде частиц сферической формы. Method and apparatus for dispensing spherical–shaped quantities of liquid solder: Пат. 5229016 США, МКИ5 B 22 D 37/00 / Hayes Donald J., Boldman Michael T., Wallace David B.; MicroFab Technologies, Inc.– № 742362; Заявл. 08.08.91; Опубл. 20.07.93; НКИ 222/590.
2. Разработки в области формирования контактов из припоя для многокристальных модулей. Development of solder bump fabrication in multiCHIP modules / Okuyama Shoichi, Nitta Tetsuji, Kanno Takeo, Terashima Minoru // IEMT 1992: 12th Int. Elec. Manuf. Technol. Symp., Mainz, Apr. 1–3, 1992; Proc. Eur. IEMT Symp.– [Durnau], 1992.– c.315–320.
3. Способ нанесения припоя. Solder particie deposition: Заявка 2269335 Великобритания, МКИ5 B 23 K 3/06 / Boyd Alexander, French William, Lees strewart P., Murray Kenneth Skane, Robertson Brian L.; IBM Corp.– № 92165265; Заявл. 04.08.92; Опубл. 09.02.94; НКИ B3R.
4. Способ совмещения и монтажа шариков припоя на подложку. Method of aligning and mounting solder balls to a substrate: Пат. 5118027 США, МКИ5 H 01 L 21/60 / Braun Carol, Corella George C., Konecke–Lease Sheila, Cummings Richard W.; IBM Corp.– № 690731; Заявл. 24.04.91; Опубл. 02.06.92; НКИ 228/180/2.
5. Машина для расстановки шариков припоя. Solder ball placement machine: Пат. 5540377 США, МПК6 B 23 K 3/06 / Ito Carl T.– № 276171; Заявл. 15.07.94; Опубл. 30.07.96; НКИ 228/41.
6. Способ переноса шариков из припоя на полупроводниковый кристалл. Method of transferring solder balls onto a semiconductor device: Пат. 5219117 США, МПК5 B 23 K 35/14 / Lin Paul T.; Motorola, Inc.– № 786629; Заявл. 01.11.91; Опубл. 15.06.93; НКИ 228/253.
7. Способ установки шарика припоя. Selictive addition of a solder ball to an array of solder balls: Пат. 5425493 США, МПК6 H 01 L 21/607 / Interrante Mario J., Economikos Laertis; IBM Corp.– № 288520; Заявл. 10.08.94; Опубл. 20.06.95; НКИ 228/110.1.
8. Способ формирования соединительных выступов. Method of forming bonding bumps by punching a metal ribbon: Пат. 5275970 США, МКИ5 H 01 L 21/283 / Itoh Masataka, Hoamou Hiroshi; NEC Corp.– № 777903; Заявл. 17.10.91; Опубл. 04.01.94; Приор. 17.10.90, № 2–278088 (Япония); НКИ 437/183.
9. ИС, имеющая матрицу из копларных контактов в виде шариков припоя. Integrated circuit having a corlanar solder ball contact array: Пат. 5435482 США, МПК6 H 01 L 21/603 / Variot Patric, Chia Chok J., Trabucco Robert T.; LSI Logic Corp.– № 192081; Заявл. 4.02.94; Опубл. 25.07.95; НКИ 228/254.
10. Способ монтажа кристалла ИС. Заявка 2133937 Япония, МКИ5 H 01 L 21/60 / Абэ Сунао; Арупусу дэнки к. к. – № 63-288103; Заявл. 15.11.88; Опубл. 23.05.90 // Кокай токкë кохо. Сер. 7 (2). – 1990.– 125. – с. 197-200.
11. Способ изготовления контактной площадки. Process of making pad structure for solder ball limiting metallurgy having reduced edge stress: Пат. 5376584 США, МКИ5 H 01 L 21/44 / Agarwala B. N.; IBM Corp.– № 998982; Заявл. 31.12.92; Опубл. 27.12.94; НКИ 437/183.
12. Формирование контактных выступов для сборки по методу перевернутого кристалла. Providing solder bumps for use in flip–chip bonding: Заявка 2255672 Великобритания, МКИ5 H 01 L 21/44 / Parker James Wilson, Harrison Paul Mark, Peall Robert George; Northern Telecom Ltd.– № 91101550; Заявл. 10.05.91; Опубл. 11.11.92; НКИ H1K.
13. Способ формирования столбиков припоя в технологии полупроводниковых приборов. Method for forming solder bumps in semiconductor devices: Пат. 5508229 США, МПК6 H 01 L 21/44 / Baker M. H., National Semiconductor Corp.– № 248409; Заявл. 24.05.94; Опубл. 16.04.96; НКИ 437/183.
14. Способ изготовления контактных выступов на полупроводниковом кристалле. Method and making semiconductor bonding bumps using metal cluster ion deposition: Пат. 5156997 США, МКИ5 H 01 L 21/288 / Kumar Nalin, Goruganthu Rama R., Ghazi Mohammed K.; Microelectronics and Computer Technology Corp. Hughes Aircraft Co.– № 653609; Заявл. 11.02.91; Опубл. 20.10.92; НКИ 437/183.
15. Система металлизации, состоящая из барьерного слоя силицида вольфрама со столбиковыми выводами из припоя Au/Sn эвтектического состава. Au-Sn solder bumps with tungsten silicide based barrier metallization schemes / Pittroff W., Reiche T., Barnikow J., Klein A., Merkel U., Vogel K., Würfl J. // Appl. Phys. Lett.– 1995.– 67, № 16. – c.2367–2369.
16. Способ изготовления полупроводникового прибора с металлическими выводами. Metal bump type semiconductor device and method for manufacturing the same: Пат. 5143865 США, МКИ5 H 01 L 21/28 / Hideshima Makoto, Tsunoda Tetsujiro, Kojima Shinjiro, Ando Masaru; K. K, Toshiba.– № 731392; Заявл. 17.07.91; Опубл. 01.09.92; Приор. 02.09.88, № 63–219726 (Япония); НКИ 437/183.
17. Сборка по методу перевернутого кристалла с использованием многослойных золотых контактных выступов. Development of a new flip-chop bonding process using multi-stacked m-Au bumps / Suwa Motoo, Takahashi Hiroyuki, Kamada Chiyoshi, Nishiuna Masahiko // 44th Electron. Compon. And Technol. Conf., Washington, D. C., May 1–4, 1994.: Proc. Vol. I.– [Washington (D. C.)], [0.0.94].– c.906–909.
18. Коаксиально расположенные выступы кристалла и подложки. Coaxial die and substrate bumps: Пат. 5347086 США, МКИ5 A 05 K 1/00 / Potter Curtis N., Gibson David A., Ghoshal Uttam S.; Microelectronics and Computer Technology Corp.– № 856501; Заявл. 24.03.92; Опубл. 13.09.94; НКИ 174/261.
19. Способ изготовления пленочного носителя. Пат. 5388327 США, МКИ6 H 05 K 3/34. Заявл. 15.09.93; Опубл. 14.02.95; НКИ 29/830.
20. Способ изготовления выводов ИС. Surface mount solder assembly of leadless integrated circuit packages to substrates: Пат. 5346118 США, МКИ5 H 05 K 3/34 / Degani Yinon, dudderar Thomas D., Woods William L. (Jr); AT and T Bell Lab.– № 128492; Заявл. 28.09.93; Опубл. 13.09.94; НКИ 228/180.22.
21. Конструкция электрода в форме выступа. Bump electrode structure and semiconductor chip having the same: Пат. 5289038 США, МКИ5 H 01 L 29/06 / Amano A., Fuji Electric Co., Ltd.– № 967400; Заявл. 28.10.92; Опубл. 22.02.94; Приор. 30.10.91, № 3–283367 (Япония); НКИ 257/780.
22. Формирование паяных выступов на кристалле ИС. Solder bumping of integrated circuit die: Пат. 5281684 США, МКИ5 С 23 С 26/00 / Moore Kevin D., Missele Carl; Motorola, Inc.– № 876147; Заявл. 30.04.92; Опубл. 25.01.94; НКИ 427/96.
23. Полупроводниковый прибор. Заявка 254945 Япония, МКИ5 H 01 L 21/60 / Хамамура Кёто; К. к. Тщышба.– № 63–205973; Заявл. 19.08.88; Опубл. 23.02.90 // Кокай токкë кохо. Сер. 7 (2). – 1990.– 53. – с. 263–267.
24. Невский А.Б., Платонов С.К., Соколова В.Н. Особенности конструкции и применения бескорпусных полупроводниковых приборов со столбиковыми выводами из припоя // Электронная техника. Сер. 3. Микроэлектроника. 1976. Вып. 1. С. 89-91.
25. Воронов И.К., Сейсян Р.П. Исследование механизмов отказов столбиковых выводов в интегральных схемах // Электронная техника. Сер. 8. Управление качеством, стандартизация, метрология, испытания. 1982. Вып. 3. С. 51-55.
26. Изготовление контактных выступов из припоя: Заявка 252436 Япония, МКИ Н 01 L 21/321. Заявл. 17.08.88. Опубл. 22.02.90.
27. Способ создания столбиков припоя на подложке и литниковая система для осуществления способа: Заявка 2792861 Франция, МПК7 В 23 К 3/06, Н 05 К 3/34. Заявл. 30.04.99. Опубл. 03.11.00.
28. Создание контактного столбика: Заявка 1256154 Япония, МКИ4 Н 01 L 21/92. Заявл. 06.04.88. Опубл. 12.10.89.
29. Зенин В.В., Беляев В.Н., Сегал Ю.Е. Способ изготовления контактных столбиков на полупроводниковом кристалле. Патент 2207660 RU, H 01 L 23/48. Заявл. 27.12.01. Опубл. 27.06.03. Бюл. № 18.
30. Формирование контактных выступов. Заявка 212919 Япония, МКИ5 H 01 L 21/321 / Мацумура Ясуо; Кансай Ниппон дэнки к. к. – № 63-164563; Заявл. 30.06.1988; Опубл. 17.01.1990 // Кокай токкë кохо. Сер. 7 (2). – 1990.– 16. – с. 113-116.
31. Веревкин А. Т. Основные результаты опытно-экспериментальной эксплуатации установок формирования микровыводов (УФМ-1) и монтажа кристаллов (УМК-1) // Прецизионное оборудование и технологии производства изделий микро- и радиоэлектроники. Тез. докл. Минск, 12 – 13 октября 2004, с. 80 – 81.
32. Головин В.М., Петухов И.Б. Устройство для образования шарика при микросварке: Патент 1580692 RU, В 23 К 11/24. Заявл. 06.12.88. Опубл. 30.10.94. Бюл. № 20.
33. Головин В.М., Петухов И.Б., Рыдзевский А.П., Басенко В.И., Яковлев И.П. Устройство для образования шарика при микросварке: А.с. 1289004 СССР, В 23 К 11/24 // В 23 К 101:40. Заявл. 10.06.85. Опубл. 30.09.94. Бюл. № 18.
34. Способ монтажа кристалла на подложку. Semiconductor chip bonded to a substrate and method of making: Пат. 5385869 США, МКИ5 H 01 L 21/60 / Lin Jay J., Berg Howard M., Hawkins George W.; Motorola, Inc.– № 94735; Заявл. 22.07.93; Опубл. 31.01.95; НКИ 437/209.
35. Способ изоляции при монтаже перевернутых кристаллов. Apparatus for isolation of flux materials in «flip chip» manufacturing: Пат. 5111279 США, МПК6 H 01 L 23/02 / Pasch Nicholas F., Sahakian Vahak K., Dell¢Oca Contrad J.; LSI Logic Corp.– № 576182; Заявл. 30.08.90; Опубл. 05.05.92; НКИ 357/81.
36. Способ изготовления полупроводниковых приборов с объемными выводами: Пат. 1251749 Россия, МКИ5 Н 01 L 21/02 / Панин В. М., Бодунова А. С., Маркман Л. М., Алексахин Н. Н.; Гос. Предприятие Восход.– № 3860901/25; Заявл. 04.03.85; Опубл. 15.08.94, Бюл. № 15.
37. Способ соединения металлических элементов. Debondable metallic bonding method: Пат. 5234149 США, МКИ5 B 23 K 31/02 / Katz Avishay, Lee Chien-Hsun, Tal King L., AT and T Bell Lab.– № 938194; Заявл. 28.08.92; Опубл. 10.08.93; НКИ 228/123.12.
38. Полупроводниковый прибор и способ его изготовления со сборкой по методу перевернутого кристалла. Semiconductor device utilizing a face–down bonding and a method for manufacturing the same: Пат. 5071787 США, МКИ5 H 01 L 21/44 / Mori Miki, Saito Masayuki; K. K, Toshiba.– № 477504; Заявл. 09.02.90; Опубл. 10.12.91; Приор. 14.03.89, № 1–61634 (Япония); НКИ 437/183.
39. Сверхминиатюрный процесс перевернутого монтажа. French develor ultraminiature flip chip process // Semicond. Int.– 1994.– 17, № 6.– c.22.
40. Способ определения положения шариковых выводов: Заявка 281449 Япония, МКИ5 H 01 L 21/60 / Ивата Хисафуми, Номото Минэо, Накагава Ясуо, Мацуока Масато; К. к. Хитати сэйсакусё.– № 63–232425; Заявл. 19.09.88; Опубл. 22.03.90 // Кокай токкë кохо. Сер. 7 (2). – 1990.– 75. – с. 225–229.
41. Механические свойства материалов межсоединений для электронного корпусирования. The mechanical behavior of Interconnect materials for electronic packaging / Frear D. R. // JOM: J. Miner., Metals and Mater. Soc/ (J. Metals)/– 1996/– 48, № 5.– с. 49–53.
42. Способ отвода тепла от кристалла с шариковыми выводами контролируемой формы. Method of heatsinking a controlled collapse chip connection device: Пат. 55523260 США, МПК6 H 01 L 21/60 / Missele C.; Motorola, Inc.– № 435555; Заявл. 05.05.95; Опубл. 04.06.96; НКИ 437/209.
Дата добавления: 2015-10-23; просмотров: 122 | Нарушение авторских прав
| <== предыдущая страница | | | следующая страница ==> |
| Формирование шариковых выводов оплавлением проволоки | | | Случай абсолютного преимущества |