
Читайте также:
|
Методические указания к лабораторной работе
МЕТОДЫ КОНТРОЛЯ ОПТИЧЕСКИХ ПАРАМЕТРОВ ДИЭЛЕКТРИЧЕСКИХ ТОНКИХ ПЛЕНОК
Специальность 200204
Москва, 2006 г.
АННОТАЦИЯ
Данные учебно-методические указания предназначены для студентов специальности 200204, выполняющих работу "Методы контроля оптических параметров диэлектрических тонких пленок".
В процессе лабораторной работы студенты должны изучить цветовой, интерференционный и эллипсометрический методы контроля толщины и показателя преломления тонких пленок и освоить методику их измерения на микроинтерферометре МИН-4 и эллипсометре ЛЭФ-ЗМ.
Автор: доцент кафедры ПР-6 Гриднева Г.Н.
Рецензент: доцент кафедры ПР-5 Новокрещенова А.С. Научный редактор: доцент кафедры ПР-6 Волков С.В.
Цель лабораторной работы - изучение методов контроля толщины и показателя преломления тонких диэлектрических пленок на кремниевой подложке.
В процессе лабораторной работы студенты должны изучить цветовой, интерференционный и эллипсометрический методы контроля тонких пленок и освоить методику измерения толщины тонких пленок на микроинтерферометре МИН-4 и эллипсометре ЛЭФ-ЗМ-1.
1. ОСНОВНЫЕ ПОЛОЖЕНИЯ
Изучение свойств тонких диэлектрических пленок имеет важное значение как для фундаментальных, так и для прикладных исследований. При отработке режимов технологических процессов нанесения диэлектрических пленок и в процессе изготовления интегральных микросхем необходимо знать их толщину и показатель преломления.
Для измерения толщины диэлектрических пленок применяются в основном цветовой, интерференционный и эллипсометрический методы.
1.1. Цветовой метод [1,5].
Цветовой метод используется для экспресс-контроля толщины пленок SiO2 и Si3N4 до 1,5 и 0,33 мкм соответственно. Он основан на окрашивании пленок разных толщин в разные цвета за счет интерференции в них одной из составляющих белого цвета, длина волны которой кратна толщине пленки. Из таблицы 1.1 видно, что через некоторый диапазон толщин (например, для SiO2 - 0,16-0,24 мкм, для Si3N4 - 0,12 - 0,14 мкм) цвета повторяются. Порядковый номер каждого.диапазона
соответствует порядку отражения. Точность определения толщины пленки данным методом 100 - 200 А.
Таблица 1.1
Цвета пленки SiO2 и Si3N4 в зависимости от их толщины.
| SiO2 | |||
| Порядок интерференции | толщина, мкм | Цвет | |
| 0,05 | Бежеватый | ||
| 0,07 | Коричневый | ||
| 0,10 | Темно-фиолетовый | ||
| 0,12 | Голубой | ||
| 0,15 | Светло-голубой | ||
| 0,17 | Цвет кремния | ||
Продолжение табл.1.1
| Порядок интерференций | Толщина, мкм | Цвет | |
| 0,20 | Светло-золотистый | ||
| 0,22 | Золотистый | ||
| I | 0,25 | Оранжевый | |
| 0,27 | Красно-фиолетовый | ||
| 0,30 | Фиолетово-голубой | ||
| 0,31 | Голубой | ||
| 0,32 | Зелено-голубой | ||
| 0,34 | Светло-зеленый | ||
| 0,35 | Зеленый | ||
| II | 0,36 | Желто-зеленый | |
| 0,37 | Зелено-желтый | ||
| 0,39 | Желтый | ||
| 0,41 | Светло-оранжевый | ||
| 0,42 | Розовый | ||
| 0,44 | Фиолетово-красный | ||
| 0,46 | Красно-фиолетовый | ||
| 0,47 | Фиолетовый | ||
| 0,48 | Голубовато-фиолетовый | ||
| 0,49 | Голубой | ||
| 0,50 | Голубовато-зеленый | ||
| III | 0,52 | Зеленый | |
| 0,54 | Желто-зеленый | ||
| 0,56 | Зелено-желтый | ||
| 0,58 | Светло-оранжевый | ||
| 0,60 | Розовый | ||
| 0,63 | Фиолетово-красный | ||
| 0,68 | Голубой | ||
| 0,72 | Голубовато-зеленый | ||
| 0,77 | Желтоватый | ||
| IV | 0,80 | Оранжевый | |
| 0,82 | Желтовато-розовый | ||
| 0,85 | Светло-красно-фиолетовый | ||
Продолжение табл. 1.1
| Порядок интерференции | Толщина, мкм | Цвет | |
| V | 0,86 | Фиолетовый | |
| 0,87 | Голубовато-фиолетовый | ||
| 0,89 | Голубой | ||
| 0,92 | Голубовато-зеленый | ||
| 0,95 | Желто-зеленый | ||
| 0,97 | Желтый | ||
| 0,99 | Оранжевый | ||
| 1,00 | Розовый | ||
| 1,02 | Фиолетово-красный | ||
| 1,05 | Красно-фиолетовый | ||
| 1,06 | Фиолетовый | ||
| 1,07 | Голубовато-фиолетовый | ||
| VI | 1,10 | Зеленый | |
| 1,11 | Желто-зеленый | ||
| 1,18 | Фиолетовый | ||
| 1,19 | Красно-фиолетовый | ||
| 1,21 | Фиолетово-красный | ||
| 1,25 | Оранжевый | ||
| 1,28 | Желтоватый | ||
| VII | 1,32 | Светло-зелено-голубой | |
| 1,40 | Оранжевый | ||
| 1,45 | Фиолетовый | ||
| 1,46 | |||
| VIII | 1,50 | Голубовато-фиолетовый | |
| 1,54 | Желто-зеленый | ||
| Нитрид кремния Si3N4 | |||
| 0-0.02 | Цвет кремния - стальной | ||
| I | 0,02-0,04 | Коричневый | |
| 0,04-0,055 | Золотисто-коричневый | ||
| 0,055-0,073 | Красный | ||
Продолжение таблицы. 1.1
| Порядок интерференции | Толщина, мкм | Цвет | |
| 0,073-0,077 | Темно-голубой | ||
| 0,077-0,093 | Голубой | ||
| II | 0,093-0,1 | Бледно-голубой | |
| 0,1-0,12 | Кремния | ||
| 0,12-0,13 | Светло-желтый | ||
| 0,13-0,15 | Желтый | ||
| 0,15-0,18 | Оранжево-красный | ||
| 0,18-0,19 | Красный | ||
| 0,19-0,21 | Темно-красный | ||
| III | 0,21-0,23 | Голубой | |
| 0,23-0,25 | Голубовато-зеленый | ||
| 0,25-0,28 | Светло-зеленый | ||
| 0,28-0,3 | Оранжево-желтый | ||
| 0,3-0,33 | Красный | ||
1.2. Интерференционный метод [2,5].
Интерференционный метод определения толщины диэлектрических пленок основан на интерференции лучей, отраженных от поверхности пластины и пленки. Эти измерения могут быть проведены с разрушением и без разрушения пленки. В первом случае часть пленки стравливают и получают ступеньку. В поле зрения микроинтерферометра НИИ-4 наблюдают интерференционную картину (рис. 1.1,а).
Если целостность пленки не нарушать, то интерференционная картина будет другой (рис. 1.l,б). Когда система интерференционных полос от пучка, отраженного поверхностью пленки, имеет слабую интенсивность, напыляют на ступеньку тонкий (2OO-300 А) сдой алюминия, который усиливает интенсивность картины и, кроме того, делает пленку прозрачной.
Расчет толщины d пленки производят по одной из формул:
[1.1]
Интерференционные картины при контроле толщины диэлектрических пленок [5]:
1- от поверхности пластины, покрытой пленкой;
2- от чистой поверхности;
3- от поверхности пленки.

Рис.1.1.
где N1 - расстояние между одинаковыми по цвету интерференционными полосами от поверхности чистой пластины и от нее же после прохождения через пленку;
N2 - расстояние между одинаковыми полосами от поверхности
пленки и чистой пленки на ступеньке;
n - показатель преломления материала пленки;
i - расстояние между соседними полосами.
Погрешность интерференционного метода связана с ошибкой при измерении по шкале микроокуляра расстояний N1 и N2 - и i и составляет 10%, а при малых толщинах пленок может достигать 50%.
1.3. Эллипсометрический метод [2,3].
Эллипсометрический метод определения толщины и оптических постоянных споев на диэлектрических, полупроводниковых и металлических подложках основан на измерении изменений состояния поляризации монохроматического поляризованного светового пучка при его отражении от системы слой — подложка или прохождении через нее. Эллипсометрия является наиболее точным методом измерения параметров тонких (толщиной 10 — 100 нм) и сверхтонких (толщиной от десятых долей до нескольких нанометров) слоев, контроля равнотолщинности и однородности слоев по площади, а также изучения процессов роста слоев. Тонкие и сверхтонкие слои, например, окисные слои на поверхностях полупроводников широко используются в полупроводниковой микро- и оптоэлектронике. Теория эллипсометрического метода базируется на использовании формул Френеля. Пусть на слой, нанесенный на подложку, падает параллельный пучок линейно поляризованного света с амплитудой E0 (рис. 1.3, а). Проекции E0 на плоскость падения и плоскость, ей перпендикулярную, составляют E½½ и E^. Так как амплитудные коэффициенты отражения системы слой — поверхность подложки (r½½)13, и (r^)13 в общем случае поглощающего слоя на произвольной подложке являются различными комплексными величинами, то амплитуда напряженности электрического поля (Er) отраженного пучка имеет другую величину и ориентацию, а отроенный пучок становится эллиптически поляризованным (рис. 1.3 а).
Отражающие системы

а) Система «подложка - однородная пленка»
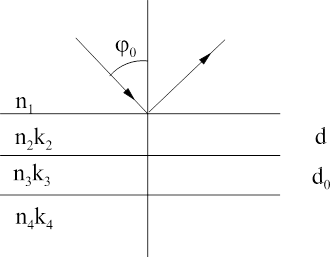
б)Система «подложка с двумя однородными пленками».
Рис. 1.2
Для описания изменения состояния поляризации при отражении от системы слой — поверхность подложки используется основное уравнение эллипсометрии, которое обычно записывается в виде:

Рис. 1.3 Изменение состояния поляризации при отражении света от поверхности подложки с покрытием.
(1.2)
где;; здесь  и
и  - скачки фазы световой волны при отражении для соответствующей поляризации падающей волны.
- скачки фазы световой волны при отражении для соответствующей поляризации падающей волны.
Углы y и D, характеризующие относительный коэффициент отражения, обычно называются поляризационными углами или эллипсометрическими параметрами. D - фазовый угол между параллельной и перпендикулярной компонентами отраженной волны. y - азимут восстановленной линейной поляризации. Через формулы Френеля параметры D и y связаны неявными математическими зависимостями с показателем преломления n1 окружающей среды, физическими характеристиками слоя d2, n2, k2 и подложки n3, k3, длиной световой волны l и углом падения j. Эту связь можно записать в виде следующей системы двух уравнений:
(1.3)
В простейшем случае прозрачного слоя при известных параметрах подложки и фиксированных j и l поляризационные углы y и D представляют собой периодические функции с периодом. Поэтому между значениями углов y и D и параметрами слоя n2, d2 в пределах интервала толщин 0 £ d2 £ D существует взаимно однозначное соответствие.
При произвольной толщине слоев ее значение определяют с точностью до периода интерференции, который должен быть известен из других измерений, а метод эллипсометрии используют для уточнения значения толщины. На практике удобно пользоваться системой графиков, рассчитанных и построенных заранее для различных наборов d2 и n2.
Данному методу присущи такие качества, как высокая точность измерений (~50 А), малая чувствительность к внешним воздействиям, отсутствие разрушающего воздействия.
Численное решение основного уравнения эллипсометрии для системы «кремниевая подложка - диэлектрическая пленка».

l = 6328 А; j0 = 70°; n2 = 3.9; k2 = 0.02; n1 = 1.3¸2.48
Рис. 1.4
Принципиальная схема прибора ЛЭФ-3М-1

1 - основание, 2 - предметный столик, 3 - плечо поляризатора, 4 - плечо анализатора, 5 - электронный блок, 6 - индикатор, 7 - опора, 8 - направляющая, 9 - кронштейн, 10 - ручка перемещения кронштейна, 11 - ручка фиксации кронштейна, 12-15 экраны, 16 - жгут патрона лампы подсветки.
Рис. 1.5
1.4. Устройство эллипсометра ЛЭФ-ЗМ-1 [6].
Лазерный фотоэлектрический эллипсометр предназначен для измерения изменений в состоянии поляризации монохроматического пучка света, возникающих в результате взаимодействия этого пучка с исследуемым образцом,
Технические данные.
Допускаемая основная абсолютная погрешность отсчета угломерного головки угла падения пучка света на образец ±0,02°.
Допускаемая основная абсолютная погрешность при измерении поляризационных углов ±0,08°.
Чувствительность измерительного тракта при минимальной интенсивности пучка света должна быть не менее 10.
Диапазон изменения угла падения пучка света на образец от 45° до 90°.
Эллипсометр (рис. 1,5) состоит из основания 1, предметного столика 2, плеча поляризатора 3, плеча анализатора 4, блока электронного 5, индикатора 6. На передней части основания 1 имеется вертикальная направляющая 8 типа "ласточкин хвост", по которой перемещается кронштейн предметного столика 9. Перемещение кронштейна осуществляется спаренной ручкой 10, а его фиксация в нужном положении - ручкой II • Плечо поляризатора 3 представляет собой корпус с расположенными в верхней части экранами 12 и 13. Внутри корпуса расположен поляризатор о устройством поворота, а также компенсатор с поворотным устройством и микрообъективом для отсчета угла поворота компенсатора. За корпусом расположен лазер. Плечо анализатора 4 представляет собой корпус с расположенными в верхней части экранами 14 и 15. В передней части корпуса расположены: ручка переключателя индикации, при помощи которой изображение выводится на экран 14.
В основу принципа действия эллипсометра положен "нулевой оптический метод, который предусматривает в данном случае достижение минимальной интенсивности пучка света на выходе анализатора неочередных поворотов поляризатора и анализатора. Угловое положение компенсатора при измерениях фиксируется так, чтобы его "быстрая" ось под углом + 45° или под углом -45° к плоскости падения пучка света на образец: это дает упрощение процедуры расчета значений поляризационных углов D и Y на заключительной стадии измерения. В каждом фиксированном рабочем положении компенсатора имеются две независимые комбинации угловых положений поляризатора и анализатора, в которых может быть достигнута минимальная интенсивность пучка света. Еще две комбинации имеются при повороте на 180° поляризатора и анализатора. В общем для четырех положений компенсатора таких комбинаций 16. Из них независимые четыре, что и обуславливает четыре измерительные зоны (i = 1,2,3,4).
Юстировочные параметры положения "быстрой" оси для данного прибора следующие:
P0 = 90°5’
A0 = 0°5’
C0 = 90°6’
Исходя из того, что C0 = 90°6, а измерение проводится при С = C0 + 45°, то расчет D и Y производится для первой зоны по следующим формулам:
D = PI + PII (1.4)
Y = 0.5 [AI +(180° - AII)] (1.5)
где P0 - угловое положение поляризатора, при котором его направление пропускания совпадает с плоскостью падения рабочего пучка излучения;
A0 - угловое положение анализатора, при котором его направление пропускания совпадает о плоскостью падения рабочего пучка излучения;
C0 - угловое положение компенсатора, расположенного между поляризатором и анализатором, при котором происходит гашение излучения, прошедшего через поляризатор в положение P0, анализатор в положении A0 + 90°;
при этом главные оси компенсатора совпадает с плоскостью падение рабочего пучка излучения и плоскостью перпендикулярной ей.
Плоскость падения - плоскость, содержащая в себе падающий луч, отраженный луч и нормаль к поверхности, на которую падает луч.
2. Методика проведения измерений на эллипсометре ЛЗФ-ЗМ-1»
1. Ознакомиться о устройством эллипсометра и с разрешения преподавателя включить шнур в сеть.
2. Включить тумблер "Сеть" на панели управления прибором. Загоревшаяся лампочка означает включение прибора.
3. Установить ручку переключателя зеркала в верхнее положение»
4. Установить механизмом подъема плеч угол подъема, равный 140°. Наблюдая за этим на экране 13 путем нажатия кнопки "Угол".
5. Установить компенсатор в положение C1 =C0 + 45° (135°6’), наблюдая за установкой в отсчетный микроскоп.
6. Установить на предметный столик исследуемый образец.
7. Подъемом или опусканием предметного столика добиться, чтобы отраженный от образца луч попадал в центр диафрагмы, расположенной на плече анализатора. На экране 14 появится световое пятно.
8. Вращением поворотных винтов, находящихся на предметном столике добиться центричнооти светового пятна (в центре светового пятна должно располагаться черная точка). Точность данной установки будет влиять на точность измерений.
9. Медленным и плавным поворотом анализатора и поляризатора добиться полного гашения пятна света на экране 14.
10. Переключить ручку поворота зеркала на плече анализатора во вт второе положение.
КАТЕГОРИЧЕСКИ ЗАПРЕЩАЕТСЯ ПЕРЕКЛЮЧАТЬ РУЧКУ ПРИ НЕПОГАШЕННОМ ПЯТНЕ НА ЭКРАНЕ. ЭТО МОЖЕТ ПРИВЕСТИ К ПОЛОМКЕ И ВЫХОДУ ИЗ СТРОЯ ЭЛЛИПСОМЕТРА.
II. Нажать один раз (поворотное нажатие увеличит чувствительность) кнопку "АРУ" на пульте управления и осторожным небольшим вращением анализатора и поляризатора добиться минимального значения тока на микроамперметре.
Нажать кнопку "Сброс" и переключить ручку поворота зеркала в исходное положение.
13. Путем попеременного нажатия кнопок "A" и "P" снять с экранов 12 и 15 значение углов поворота поляризатора и анализатора AI и PI. AI и PI не должны превышать 180° при несоответствии этому условию необходимо повернуть поляризатор или анализатор (в зависимости от значений A и P) на угол 180° и повторять п.п. 9-13.
14. Установить угол поворота поляризатора PII = PI ± 90° путем поворота поляризатора в ту или иную сторону, наблюдая по экрану 12 за значением угла (при нажатой кнопки "P").
15. Добиться гашения светового пятна на экране 14, путем медленного поворота анализатора.
16. Переключить ручку поворота зеркала на плече анализатора во второе положение. Выполнить п.п. 11-12.
17. Снять значения угла поворота анализатора A c экрана 15 путем нажатия кнопки A.
Произвести измерения необходимо в трех точках. После чего включить прибор.
18. Произвести расчет углов D и Y по формулам (1.4) и (1.5).
По программе «Ellips» произвести расчет оптических параметров образца. Согласуя с цветовым методом, определить полную толщину исследуемой пленки.
2. МЕТОДИКА ПРОВЕДЕНЫ ЛАБОРАТОРНОЙ РАБОТЫ
1. Получить у преподавателя исследуемые образцы.
2. Провести измерения по цветовому методу и полученные данные занести в таблицу 2.3.
3. Провести измерение по интерференционному методу на микроинтерферометре МИИ-4, полученные данные занести в таблицу 2.3.
4. Провести измерение по эллипсометрическому методу на эллипсометре ЛЭФ 3М-1, полученные данные занесены в таблицы 2.2. 2.3. Пользуясь программой “Ellips”(таблица 2.1), произвести расчет параметров измеряемой пленки n, d, и d0. Полученные значения занести в таблицы 2.2 и 2.3.
Таблица 2.1.
Внешний вид программы “Ellips”
| fi0 | n0 | n2 | nbegin | nend | ||||||||
| Re | Im | Re | Im | Re | Im | Re | Im | |||||
| 1.0000 | 0.0000 | 3.9500 | 0.0200 | 1.300 | 0.0000 | 2.0000 | 0.0000 | |||||
| lumbda | mistake | psi | delta | n | d | d0 | ||||||
| 6328.0 | 0.00010 | 1.690257 | 792.92476 | 2251.774918 | ||||||||
5. Сравнить результаты измерений по трем методам и сделать выводы о точности измерения этих методов.
Таблица 2.1
Измерение оптических параметров диэлектрических пленок эллипсометрическим методом.
| ¹¹ | Угол | Угол | Угол | Угол | Угол | Угол | программа | |||||||||
| (град) PI | (град) PII | (град) AI | (град) AII | (град) y | (град) D | d (А) | n | |||||||||
Таблица 2.2
Сводная таблица трех методов контроля оптических параметров диэлектрических пленок.
| ¹¹ | Эллипсометрический метод | Цветовой метод | Интерференционный метод | |||||||||||||||||
| y | D | программа | Цвет | порядок отраж. | d (А) | N1 | N2 | d (А) | ||||||||||||
| d (А) | n | |||||||||||||||||||
3. СОДЕРЖАНИЕ ОТЧЕТА
1. Краткое положение физической сущности каждого из методов контроля.
2. Структурная схема эллипсометра.
3. Таблица результатов измерений.
4. Выводы.
4.КОНТРОЛЬНЫЕ ВОПРОСЫ.
1. Какие физические величины непосредственно измеряются эллипсометром?
Чем обусловлена высокая точность определения толщины методом эллипсометрии?
3.Каково назначение анализатора, поляризатора и компенсатора?
4.Чем вызвана необходимость применения лазера в качестве источника света в эллипсометре?
5.В каких случаях при интерференционном методе контроля напыляют алюминий.
6.В чем сущность цветового и интерференционного методов контроля толщины диэлектрических пленок?
7.С чем связана погрешность измерения толщины пленок цветовым и интерфериционным методами?
СПИСОК ЛИТЕРАТУРЫ
1. Крылова Т. Н. Интерференционные покрытия. П.: Машиностроение, 1973.224 с.
2. Основы эллипсометрии / А. В. Ржанов, К. К. Свиташев, А. И. Семененко и др. Новосибирск: Наука, Сибирское отделение, 1979.423 с.
3. Технология тонких пленок. Справочник / Пер. с англ.; Под pen. Л. Майссепа, Р. Гланга. Т. 1,2. М.: Сов. радио, 1977.
4. Физика тонких пленок / Пер. с англ.; Под рея. Г. Хасса, М. Франкомба, Р. Гофмана. Т. VIII. М.: Мир, 1978, с. 7-60.
5. С.Н.Никифорова-Денисова, Е.Н. Любушкина. Термические процессы. М.: Высшая школа, 1989. 96 с.
6. Эллипсометр ЛЭФ 3М-1. Паспорт. Техническое описание и инструкция по эксплуатации.
Дата добавления: 2015-09-05; просмотров: 407 | Нарушение авторских прав
| <== предыдущая страница | | | следующая страница ==> |
| Размытый фон | | | Мета роботи |