
|
Читайте также: |
Из анализа физических основ методов исследования поверхности, процессов эмиссии вторичных электронов и способов регистрации распределения электронов по энергии, конструкций вспомогательных устройств, обеспечивающих процесс регистрации электронов, эмитированных поверхностью твердого тела формулируются, а за тем выполняются основные требования к электронному спектрометру.
Для надежной работы электронного спектрометра система получения и контроля сверхвысокого вакуума в аналитической камере спектрометра обеспечивает вакуум порядка 10-7 … 10-8 Па. Конструкции современных магниторазрядных насосов позволяют создавать и поддерживать требуемые вакуумные условия в течение длительного времени при достаточно низких энергетических затратах.
Сверхвысоковакуумные камеры спектрометров изготавливают, как правило из нержавеющей стали и имеют достаточное количество фланцев для закрепления устройств, обеспечивающих работу спектрометра (электронных и ионных пушек, энергоанализатора и т.д.). Быстрая смена образца обеспечивается шлюзовым устройством, закрепленным на одном из фланцев аналитической камеры. С помощью вакуумных затворов шлюзовая камера отсекается от аналитической камеры, в ней производится смена образца, откачка до предварительного вакуума, после чего образец с помощью специального манипулятора перемещается в аналитическую камеру. При такой процедуре смены образца нет необходимости производить длительную операцию откачки и очистки аналитической камеры..
В аналитической вакуумной камере располагаются также электронные и ионные пушки. В некоторых спектрометрах применяется вторая электронная пушка для компенсации заряда при записи спектров в непроводящих или плохо проводящих образцах. В спектрометрах, используемых для фотоэлектронной спектроскопии, в аналитической камере располагаются источники рентгеновского или ультрафиолетового излучения.
Работа и управление энергоанализаторами, электронными и ионными пушками, регистрацией сигнала, системами нагрева и охлаждения образцов обеспечивается электронными блоками, которые могут управляться вручную, или с помощью компьютера. В современных автоматизированных комплексах для исследования поверхности компьютерная система управляет основными параметрами спектрометров, такими как кинетическая энергия первичных электронов, ток и напряжение источника рентгеновского излучения, диапазон измерений энергии вторичных электронов, число сканирований и т. д. Компьютерная система контролирует также работу аргоновой ионной пушки и позволяет автоматизировать процесс записи профилей распределения элементов по глубине. Собранные данные можно предварительно обработать с помощью компьютерной системы, произведя операции изменения масштаба спектра, измерения площадей кривых, дифференцирования спектра, устранения выбросов, вычитания постоянной составляющей, сложения и вычитания спектров, сглаживания, вычитания фона, нормировки и анализа сложных спектров, состоящих из нескольких перекрывающихся пиков разной формы и интенсивности и многие другие операции.
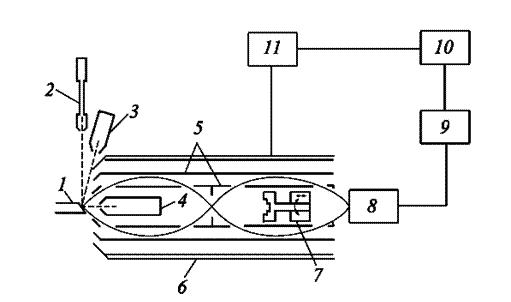
Рис.4.32. Блок –схема спектрометра РН1-550
В качестве примера на рис4.32 представлена блок-схема одного из распространенных РФЭС/ЭОС спектрометров модели PHI-550 фирмы Perkin-Elmer (США). В нем использован двухпролетный АЦЗ, пригодный как для РФЭС так и для ЭОС. Источником рентгеновских лучей служит излучение Al K a или Mg K a. Электронная пушка, являющаяся источником первичных электронов, расположена внутри анализатора на его оси. Эмитированные поверхностью твердого тела электроны, прошедшие через анализатор, регистрируются электронным умножителем и детектором импульсов, ионная пушка применяется для предварительной очистки поверхности образца и для профилирования по глубине. Управление спектрометром, контроль за его работой и количественная обработка результатов осуществляется с помощью компьютерной системы.
Разработчики оборудования для исследования поверхности твердых тел стремятся объединить в одном цикле как можно больше методов, дополняющих друг друга при получении информации о физических свойствах поверхностных атомных слоев. ЭОС используется, прежде всего, для определения элементного состава поверхности, РФЭС, СХПЭЭ дают информацию о химических связях атомов на поверхности, УФЭС - о структуре валентной зоны, ДМЭ и ДОБЭ – о кристаллографии поверхностных атомных слоев.
Энергоанализаторы с задерживающим полем предоставляют хорошую возможность для создания на их основе аппаратуры для комплексного исследования поверхности твердых тел. Конструкция этих анализаторов базируется на оптике, давно используемой в исследовании поверхности твердых тел методом дифракции медленных электронов. Поэтому спектрометры, использующие АЗП, позволяют с небольшими конструктивными доработками проводить одновременно с исследованием элементного состава и химического состояния методами ЭОС, СХПЭЭ и др., также структурные исследования поверхностных атомных слоев методом ДМЭ. Используя конфигурацию АЗП, можно коммутацией режимов работы реализовать методы спектроскопии потенциалов исчезновения, спектроскопии пороговых потенциалов и др.
На рис. 4.33 представлена блок-схема электронного спектрометра, предназначенного для комплексного исследования вторично-эмиссионных свойств поверхности твердого тела. Эта лабораторная установка уже в течение нескольких лет используется для учебных и научных целей в Сибирской аэрокосмической академии.
Сверхвысоковакуумная камера изготовлена из нержавеющей стали и имеет 10 фланцев различного диаметра. На нижнем фланце крепится магниторазрядный насос, обеспечивающий вакуум до 10-9 Торр. Предварительный вакуум создается сорбционным насосом. Контроль предварительного и высокого вакуума осуществляется соответственно термопарным и ионизационным манометрами. На верхнем фланце сверхвысоковакуумной камеры крепится манипулятор с каруселью для образцов. Держатели образцов снабжены вольфрамовыми нагревателями для очистки образцов в камере СВВ и температурных измерений. Манипулятор позволяет вращать карусель с держателями образцов вокруг вертикальной оси и с помощью трех юстировочных винтов перемещать образец в вертикальном направлении и изменять угол наклона образца относительно электронного луча. Энергоанализатор задерживающего поля с электронной пушкой расположены на одном из боковых фланцев. Коллектор энергоанализатора покрыт люминофором, что позволяет наблюдать картину ДМЭ через окно, расположенное на противоположном от энергоанализаторе фланце. Блок управления электронной пушкой позволяет получать электронный пучок до 5 мкА с энергией до 1500 эВ, разворачивать его в растр, смещать по поверхности исследуемого образца для выбора точки, в которой необходимо записать спектр вторичных электронов. Электронный спектрометр позволяет регистрировать спектр вторичных электронов в виде кривых N (E) или dN (E)/ dE. Спектр может быть записан на бланке двухкоординатного самописца или с помощью блока автоматизации записи электронных спектров на базе ПЭВМ в файл для последующей обработки стандартными пакетами прикладных программ.
Кроме записи спектров вторичных электронов в режиме электронной оже-спектроскопии, спектроскопии характеристических потерь энергии электронов, спектроскопии потенциалов исчезновения и наблюдения дифракции медленных электронов, комплекс аппаратуры позволяет изучать

Рис.4.33. Блок- схема комплекса аппаратуры для исследования вторичноэмиссионных свойств поверхности твердых тел
распределение работы выхода по поверхности образца методом электронного пучка (метод Андерсона). С этой целью на одном из боковых фланцев сверхвысоковакуумной камеры установлен электронный прожектор.
Телевизионный монитор позволяет получать изображение поверхности образца, как в режиме электронного спектрометра, так и в режиме исследования распределения работы выхода по поверхности образца.
Комплекс аппаратуры снабжен также ионной пушкой для предварительной очистки поверхности образцов и изучения профилей распределения элементов по толщине.
Переключение электронного спектрометра с одного режима работы на другой осуществляется с помощью блока коммутации, который позволяет производить в различных вариантах соединения выводов электродов электронной пушки, коллектора, сеток энергоанализатора и источников питания электронного спектрометра.

Рис.4.34. Рентгеноэлектронный спектрометр Эс-2401
На рис.4.34. показан рентгеноэлектронный спектрометр ЭС-2401 на котором проводится количественный и качественный анализ состава поверхности и профиль изменения концентрации химических элементов по глубине (с использованием методики ионного травления).Эксперименты проводятся с использованием приставок для ионного травления и индукционного нагрева образца. Возбуждение электронных спектров осуществляется рентгеноским и ультрафиолетовым излучениями. Чувствительность метода – доли моноатомных слоев
5. МИКРОСКОПИЯ ОПТИЧЕСКОЙ ПОВЕРХНОСТИ
5.1 Сравнительные характеристики микроскопов
Существует множество методов увеличения микроскопических деталей поверхности. Самым простым методом, используемым с конца 18 века, является увеличительные линзы и оптическая микроскопия. Предел разрешения оптической микроскопии ограничен длиной волны видимого света и составляет около 0,5 мкм.
В 20 веке активно развивались методы микроскопического исследования поверхности, использующие электронные и ионные пучки. Сканирующая электронная микроскопия (СЭМ) при работе в вакууме позволяет разрешать детали порядка 30 ангстрем для образцов с высоким контрастом атомного номера. Однако вследствие использования пучка высокоэнергетичных электронов этот метод повреждает исследуемую поверхность. Кроме того, он не позволяет непосредственно получать информацию о высоте деталей рельефа.
Исследование рельефа и локальных свойств поверхности в СЗМ проводится с помощью специально приготовленных механических зондов и позволяет получать трехмерное изображение поверхности на воздухе, в жидкости и в вакууме с разрешением вплоть до долей ангстрема. В таблице 5.1 приведены сравнительные характеристики различных методов микроскопического исследования поверхности. Первые четыре метода используют сфокусированный пучок частиц (фотонов, электронов и ионов) для получения увеличенного изображения, а в СЗМ производится сканирование поверхности образца острым механическим микро-зондом.
5.2 Конфокальная микроскопия
Конфокальный микроскоп отличается от «классического» оптического микроскопа тем, что в каждый момент времени регистрируется изображение одной точки объекта, а полноценное изображение строится путем сканирования (движения образца или перестройки оптической системы).
Таблица 5.1
– Сравнительные характеристики методов микроскопического исследования поверхности твердых тел
| Метод | Увеличение | Рабочая среда | Разость изображения | Поврежние образца |
| Оптическая микроскопия | 103 | воздух, жидкость | 2D | нет |
| Конфокальная, лазерная микроскопия | 104 | воздух | 2D/3D | минимальное |
| Ионная микроскопия | 105 | вакуум | 2D | сильное |
| СЭМ | 106 | вакуум | 2D | несильное |
| СЗМ | 106 | вакуум, воздух, жидкость | 3D | нет |
Для того, чтобы регистрировать свет только от одной точки после объективной линзы располагается диафрагма малого размера таким образом, что свет, испускаемый анализируемой точкой (красные лучи на рис. 5.2), проходит через диафрагму и будет зарегистрирован, а свет от остальных точек (например, синие лучи на рис. 5.2) в основном задерживается диафрагмой. Вторая особенность состоит в том, что осветитель создает не равномерную освещенность поля зрения, а фокусирует свет в анализируемую точку (рис. 5.3). Это может достигаться расположением второй фокусирующей системы за образцом, но при этом требуется, чтобы образец был прозрачным. Кроме того, объективные линзы обычно сравнительно дорогие, поэтому использование второй фокусирующей системы для подсветки мало предпочтительно. Альтернативой является использование светоделительной пластинки, так чтобы и падающий и отраженный свет фокусировались одним объективом (рис. 5.4). Такая схема к тому же облегчает юстировку.
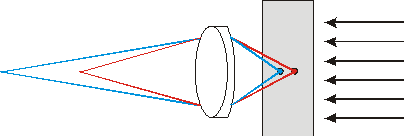
Рис. 5.1. Ход лучей в обычном оптическом микроскопе, когда в фотоприемное устройство попадает свет из различных точек образца.

Рис. 5.2. Применение диафрагмы позволяет существенно снизить фоновую подсветку от точек образца вне анализируемой области.

Рис. 5.3. Дополнительное повышение контраста достигается применением подсветки, фокусирующей свет в анализируемую точку.

Рис. 5.4. Схема со светоделительной пластинкой упрощает конструкцию микроскопа и процесс юстировки за счет двойного использования объектива (для подсветки и сбора отраженного сигнала).

Рис.5.5 Конфокальная схема микроскопа со светоделитеьной пластиной и пзс- матрицей.
Качественно понятно, что применение конфокальной схемы должно приводить к увеличению контрастности изображения, за счет того, что «паразитный» свет от точек соседних с анализируемой перестает попадать в детектор. Платой за увеличение контрастности будет необходимость применения достаточно сложных схем сканирования либо образцом, либо световым пучком.
5.2.1 Разрешение и контрастность в конфокальном микроскопе.
Рассмотрим теперь математически, каким образом и насколько количественно изменяется контрастность при применении конфокальной микроскопии. Во-первых, так как в конфокальном микроскопе свет дважды проходит через объектив, то функция размытия точки (далее обозначаемая PSF). имеет вид
 (5.1)
(5.1)
Для качественного понимания удобно рассматривать каждую PSF как вероятность того, что фотон попадет в точку с координатами  , либо что фотон будет зарегистрирован из точки с координатами
, либо что фотон будет зарегистрирован из точки с координатами  , тогда конфокальная PSF есть произведение независимых вероятностей. На рис. 5.6 приведено изображение обычной PSF и конфокальной PSF.
, тогда конфокальная PSF есть произведение независимых вероятностей. На рис. 5.6 приведено изображение обычной PSF и конфокальной PSF.

Рис.5.6. Конфокальная PSF показана справа, а обычная PSF – слева.
Если использовать критерий Релея для разрешения (провал 26% от максимума распределения), то мы получим, что разрешение в конфокальном микроскопе увеличивается, но не существенно. Для конфокального микроскопа
 (5.2)
(5.2)
в то время как для обычного микроскопа
 (5.3)
(5.3)
 |
 .Однако основным достоинством конфокального микроскопа является не увеличение разрешения в смысле критерия Релея, а существенное увеличение контрастности. В частности для обычной PSF в фокальной плоскости отношение амплитуды в первом боковом максимуме к амплитуде в центре составляет 2%, для случая конфокального микроскопа это отношение будет 0.04%. На рис. 5.7 приведен практический пример, когда это важно. На верхней части рисунка мы видим, что тусклый объект (интенсивность в 200 раз меньше, чем у яркого) не возможно обнаружить в обычный микроскоп, хотя расстояние между объектами существенно больше того, что предписано критерием Релея. В то же самое время, в конфокальный микроскоп (нижняя часть рисунка 3) данный объект должен хорошо регистрироваться. Максимум интенсивности тусклого объекта в 200 раз меньше, чем интенсивность яркого. Распределение интенсивности вдоль оптической оси для конфокального микроскопа определяется выражением
.Однако основным достоинством конфокального микроскопа является не увеличение разрешения в смысле критерия Релея, а существенное увеличение контрастности. В частности для обычной PSF в фокальной плоскости отношение амплитуды в первом боковом максимуме к амплитуде в центре составляет 2%, для случая конфокального микроскопа это отношение будет 0.04%. На рис. 5.7 приведен практический пример, когда это важно. На верхней части рисунка мы видим, что тусклый объект (интенсивность в 200 раз меньше, чем у яркого) не возможно обнаружить в обычный микроскоп, хотя расстояние между объектами существенно больше того, что предписано критерием Релея. В то же самое время, в конфокальный микроскоп (нижняя часть рисунка 3) данный объект должен хорошо регистрироваться. Максимум интенсивности тусклого объекта в 200 раз меньше, чем интенсивность яркого. Распределение интенсивности вдоль оптической оси для конфокального микроскопа определяется выражением
 (5.4)
(5.4)
Тогда пользуясь критерием Релея получим разрешение вдоль оптической оси
 (5.5)
(5.5)
Здесь важно отметить, что не следует путать разрешение вдоль оптической оси и глубину фокуса в обычном микроскопе. Обычно глубина фокуса в сотни раз превышает разрешение вдоль оптической оси.
Один из параметров, который никак не фигурировал в данном выше описании - это размер диафрагм в фокальной плоскости облучающей и собирающей линз. Отметим, что при анализе мы молчаливо предполагали источник точечным и именно в этом предположении получили функцию размытия точки (PSF) для обычного и конфокального микроскопа. Полученные PSF описывают свойства объективной линзы, а изображение диафрагмы в плоскости объекта определяет, свет из каких областей регистрируется фотодетектором. Очевидно, однако, что уменьшение размера диафрагмы приводит к уменьшению количества проходящего света, увеличивает уровень шума и, в конечном итоге, может свести на нет все достигнутые преимущества по контрастности. Таким образом, стоит вопрос об оптимальном выборе размера диафрагмы и разумном компромиссе.
Диафрагма с отверстием меньше размера пятна Эйри просто приводит к потере интенсивности и никак не влияет на разрешение. Диафрагма размером в одно пятно Эйри позволяет по максимуму использовать разрешающую способность объективной линзы. Однако размер диафрагмы примерно в 3-5 раза больше пятна Эйри представляется наиболее подходящим компромиссом. Следует понимать, что обсуждаемый здесь размер имеет смысл размера изображения в плоскости объекта, а поэтому реальный размер отверстия в диафрагме зависит от увеличения линзы. В частности, при использовании 100-кратной линзы диафрагма с отверстием 1 мм будет спроецирована в плоскость объекта в круг радиусом 10 мкм.
Результирующее распределение интенсивности для случая диафрагмы с размером 5 пятен Эйри приведено на рис. 5.8.
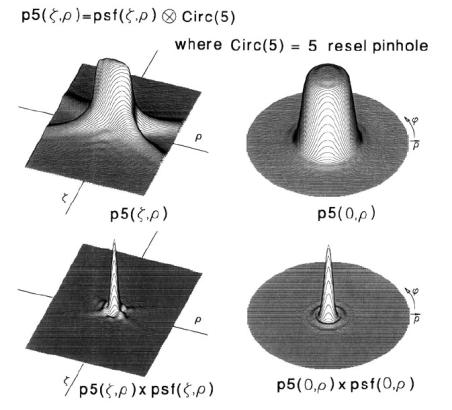
Рис. 5.8. Функции размытия точки для обычного микроскопа с диафрагмой размером 5 пятен Эйри (верхние рисунки) и для конфокального микроскопа (нижние рисунки)
Таким образом:
1. Конфокальная микроскопия обеспечивает увеличение контраста изображения за счет применения подсветки сфокусированной объективной линзой в область анализа и размещения диафрагмы в плоскости наблюдения перед фотодетектором. Такое увеличение контрастности приводит к возможности разрешения объектов, имеющих разницу в интенсивности до 200:1.
2. В конфокальной микроскопии несколько улучшается разрешение в плоскости объекта (в 1.5 раза) и достигается высокое разрешение вдоль оптической оси.
3. Платой за полученные улучшения является необходимость применения схем сканирования, либо путем перемещения образца, либо путем перестройки оптической системы. Применение сканирования позволяет увеличить поле зрения по сравнению с обычными оптическими микроскопами.
5.3. Полевая ионная микроскопия
Полевой ионный микроскоп был создан немецким учёным Э. Мюллером в 1951 году. По принципу действия ионный микроскоп аналогичен электронному микроскопу. Проходя через объект и испытывая в различных его участках рассеяние и поглощение, ионный пучок фокусируется системой электростатических или магнитных линз и даёт на экране или фотослое увеличенное изображение объекта. Для построения изображения используются ионы так называемого изображающего газа. Для получения ионов изображающего газа используется явление ионизации на поверхности металла молекул или атомов газа в сильном электрическом поле за счёт туннелирования электронов в металл. В качестве изображающего газа обычно используется гелий и другие инертные газы.
Принципиальное преимущество ионного микроскопа перед электронным заключается в том, что масса иона во много раз больше массы электрона, поэтому дебройлевская длина волны, определяемая формулой  , у такой частицы оказывается во столько же раз меньше (при одинаковом ускоряющем напряжении), что теоретически должно привести к соответствующему увеличению разрешения.
, у такой частицы оказывается во столько же раз меньше (при одинаковом ускоряющем напряжении), что теоретически должно привести к соответствующему увеличению разрешения.
В настоящее время создано лишь несколько опытных образцов ионных микроскопов. Дело в том, что получение изображения в ионном микроскопе происходит в весьма специфических условиях: бомбардировка поверхности тяжёлыми ионами приводит к искажению исследуемой поверхности, происходит быстрое «залечивание» вакансий, отрыв выступающих атомов и т. п., что приводит к получению равномерной картины с идеально упорядоченным расположением атомов. Исследование живых объектов при помощи такого микроскопа невозможно. Кроме того, под действием интенсивного ионного пучка происходит разрушение люминофора экрана.
Разновидностью ионного микроскопа можно считать ионный проектор, безлинзовый ионно-оптический прибор для получения

 Рис 5.9. Схема ионного проектора: 1 – жидкий водород; 2 – жидкий азот; 3 – остриё; 4 – проводящее кольцо; 5 – экран
Рис 5.9. Схема ионного проектора: 1 – жидкий водород; 2 – жидкий азот; 3 – остриё; 4 – проводящее кольцо; 5 – экран
увеличенного в несколько миллионов раз изображения поверхности твёрдого тела. Принципиальная схема ионного проектора показана на рис. 5.9. Положительным электродом и одновременно объектом, поверхность которого изображается на экране, служит остриё тонкой иглы. Атомы газа, заполняющего внутренний объём прибора, ионизуются в сильном электрическом поле вблизи поверхности острия, отдавая ему свои электроны. Возникшие положительные ионы приобретают под действием поля радиальное (перпендикулярное поверхности острия) ускорение, устремляются к флуоресцирующему экрану (потенциал которого отрицателен) и бомбардируют его. Свечение каждого элемента экрана пропорционально плотности приходящего на него ионного тока. Поэтому распределение свечения на экране воспроизводит в увеличенном масштабе распределение вероятности возникновения ионов вблизи острия.
Масштаб увеличения m равен отношению радиуса экрана R к радиусу кривизны острия r: m = R/r (чем тоньше остриё, тем больше увеличение).
Вблизи острия электрическое поле неоднородно – над ступеньками кристаллической решётки или отдельными выступающими атомами его локальная напряжённость увеличивается: на таких участках вероятность ионизации выше и количество ионов, образующихся в единицу времени, больше. На экране эти участки отображаются в виде ярких точек (рис. 5.10). Иными словами, образование контрастного изображения поверхности определяется наличием у неё локального микрорельефа.
Ионный ток и, следовательно, яркость и контрастность изображения растут с повышением давления газа, которое в ионном проекторе обычно не превышает примерно 0,001 мм рт. ст.
С помощью ионного проектора за счёт разрешения отдельных атомов (светлые точки на кольцах) можно различить бисерно-цепочечную структуру ступеней кристаллической решетки
Ионный проектор широко применяется для исследования атомной структуры чистых металлов и различных сплавов и её связи с их


 Рис. 5.10. Изображения поверхности вольфрамового острия радиусом 950 Å при увеличении в 106 раз в гелиевом ионном проекторе при температуре 22 К.
Рис. 5.10. Изображения поверхности вольфрамового острия радиусом 950 Å при увеличении в 106 раз в гелиевом ионном проекторе при температуре 22 К.
механическими свойствами; всевозможных дефектов в кристаллах, в частности, дислокаций и повреждений, вызванных радиоактивным облучением; влияния способов обработки, например пластических деформаций, на свойства материалов. С его помощью изучают процессы коррозии, адсорбции и десорбции, свойства тонких пленок, осаждённых на поверхности металлов. В настоящее время ведутся работы, ставящие целью изучение с помощью ионного проектора структуры биологических молекул. Разрешающая способность ионного проектора составляет 0,2–0,3 нм
5.4 Сканирующая зондовая микроскопия
Сканирующая зондовая микроскопия (СЗМ) является мощным современным методом исследования морфологии поверхности и локальных поверхностных свойств твердого тела с высоким пространственным разрешением. СЗМ - это прибор, дающий возможность исследования свойств поверхностей материалов от микронного до атомарного уровня. В настоящее время методы СЗМ активно применяются в области физики поверхности и тонкопленочных технологий. СЗМ стимулировало развитие новых методов в нанотехнологии – создание структур с нано-метровыми масштабами.
В 1981 году швейцарскими учеными Г. Биннигом и Г. Рорером был изобретен сканирующий туннельный микроскоп (СТМ) – первый из семейства зондовых микроскопов. Они показали, что это достаточно простой и весьма эффективный способ исследования поверхности с пространственным разрешением вплоть до атомарного. Настоящее признание данная методика получила после визуализации атомарной структуры поверхности ряда материалов. В 1986 году за создание туннельного микроскопа Г. Биннигу и Г. Рореру была присуждена Нобелевская премия по физике.
Вслед за СТМ были созданы атомно-силовой микроскоп (АСМ), магнитно-силовой микроскоп (МСМ), электросиловой микроскоп (ЭСМ) и многие другие, имеющие сходные принципы работы и называемые сканирующими зондовыми микроскопами.
Микроскопия (СЭМ) при работе в вакууме позволяет разрешать детали порядка 30 ангстрем для образцов с высоким контрастом атомного номера. Однако вследствие использования пучка высокоэнергетичных электронов этот метод повреждает исследуемую поверхность. Кроме того, он не позволяет непосредственно получать информацию о высоте деталей рельефа.
Исследование рельефа и локальных свойств поверхности в СЗМ проводится с помощью специально приготовленных механических зондов и позволяет получать трехмерное изображение поверхности на воздухе, в жидкости и в вакууме с разрешением вплоть до долей ангстрема.
5.4.1 Принцип работы сканирующего зондового микроскопа
В основе работы СЗМ лежат различные типы взаимодействия зонда с поверхностью образца. Характерное расстояние между зондом и образцом составляет 0,1-10 нм. Контроль этого расстояния осуществляется при помощи системы обратной связи (ОС), представленной на рисунке 5.11. 
Для реализации ОС необходима резкая и взаимнооднозначная зависимость характеристики взаимодействия зонда с поверхностью от расстояния зонд-образец V(z). В процессе работы система ОС поддерживает постоянным значение V, равным величине Vs, задаваемой оператором. При изменении расстояния зонд-  образец (вследствие изменения рельефа поверхности образца под зондом в результате перемещения зонда в плоскости XY) происходит соответствующее изменение V. В системе ОС формируется сигнал Vc, определяемый величиной ошибки Verr = V — Vs, используемый для коррекции сигнала Vz, управляющего Z-сканером (функциональным элементом СЗМ, отвечающим за прецизионное Z-позиционирование зонда над образцом), который приближает зонд к поверхности или отодвигает его до тех пор, пока Verr не станет равным нулю. В существующих СЗМ расстояние зонд-образец удается поддерживать с высокой точностью ~ 0,01
образец (вследствие изменения рельефа поверхности образца под зондом в результате перемещения зонда в плоскости XY) происходит соответствующее изменение V. В системе ОС формируется сигнал Vc, определяемый величиной ошибки Verr = V — Vs, используемый для коррекции сигнала Vz, управляющего Z-сканером (функциональным элементом СЗМ, отвечающим за прецизионное Z-позиционирование зонда над образцом), который приближает зонд к поверхности или отодвигает его до тех пор, пока Verr не станет равным нулю. В существующих СЗМ расстояние зонд-образец удается поддерживать с высокой точностью ~ 0,01  . Таким образом, система ОС отрабатывает изменения параметра V, обусловленные рельефом поверхности при перемещении зонда в плоскости XY (сканировании), при этом сигнал Vz, управляющий Z-сканером, используется для реконструкции рельефа поверхности образца.
. Таким образом, система ОС отрабатывает изменения параметра V, обусловленные рельефом поверхности при перемещении зонда в плоскости XY (сканировании), при этом сигнал Vz, управляющий Z-сканером, используется для реконструкции рельефа поверхности образца.
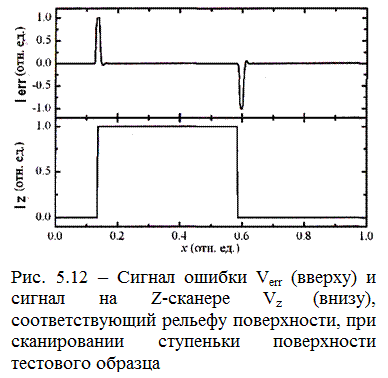 Работу системы ОС можно проследить на примере измерения рельефа ступеньки поверхности тестового образца. На рисунке 5.12 приведен сигнал на Z-сканере Vz, пропорциональный высоте рельефа поверхности, и соответствующий ему сигнал ошибки Verr в системе ОС при сканировании одиночной линии.
Работу системы ОС можно проследить на примере измерения рельефа ступеньки поверхности тестового образца. На рисунке 5.12 приведен сигнал на Z-сканере Vz, пропорциональный высоте рельефа поверхности, и соответствующий ему сигнал ошибки Verr в системе ОС при сканировании одиночной линии.
Дата добавления: 2015-07-10; просмотров: 146 | Нарушение авторских прав