
|
Читайте также: |
| Рентгеновские лучи | Энергия, эВ | Ширина линии, эВ |
| Cu Кα | 2,5 | |
| Ti Кα | 1,4 | |
| Al Кα | 0,9 | |
| Mg Кα | 0,8 |
На рис. 4.23. изображена конструкция простейшего источника рентгеновских фотонов. Анод представляет собой толстую пленку магния или алюминия, напыленную на медную пластину. Источником электронов служит термокатод, находящийся под отрицательным потенциалом до 15 кВ.
Катод окружен фокусирующим экраном, который, также как и анод заземлен. Фотоны вылетают через тонкостенное алюминиевое окно, преграждающее путь электронам и возможным загрязнениям

4.23. Источник мягкого рентгеновского излучения.
. Поскольку при бомбардировке электронами анод сильно разогревается, медная пластина, на которой напылен анод, охлаждается водой.
Часто в РФЭС используют источники рентгеновского излучения с двумя катодами и двумя анодами, один из которых изготовлен из алюминия, другой – из магния. В этом случае переключением извне питания источников электронов, бомбардирующих тот или иной анод, можно перейти от излучения Al K a к излучению Mg K a. Такое переключение необходимо при идентификации перекрывающихся фотоэлектронных линий и оже-пиков, присутствующих в фотоэлектронных спектрах. Поскольку энергия фотоэлектронных пиков смещается с изменением энергии фотонов, а положение оже-пиков не зависит от энергии возбуждающего излучения, изменение энергии рентгеновского источника дает возможность разделить эти линии.
Источники ионов. Источники ионов размещаются в сверхвысоковакуумной камере электронного спектрометра для предварительной очистки поверхности образца, а также для использования ионного травления в послойном анализе.
Простейшие ионные пушки используют конфигурацию обычного ионизационного манометра (рис. 4.24).
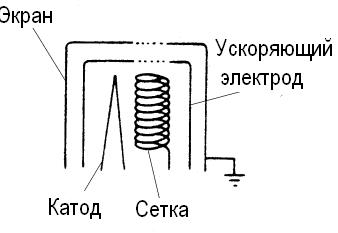
Рис.4.24. Конструкция ионной пушки.
Термокатод эмитирует электроны, которые направляются к сетке, находящейся под положительным по отношению к катоду потенциалом. Перед включением ионной пушки в систему напускают аргон при давлении 10-5 … 10-4 Торр. Ускоренные электроны, соударяясь с атомами аргона ионизуют их в околосеточном пространстве. Цилиндрический ускоряющий электрод, окружающий катод и сетку, находится, в свою очередь под отрицательным потенциалом относительно сетки. Ускоренные этим потенциалом ионы выходят через апертуру ускоряющего электрода и внешнего экрана. Варьируя потенциалы катода, сетки и ускоряющего электрода относительно земли, можно получать ионы с энергией от 200 до 500 эВ. При давлении аргона 10-4 Торр плотность ионного тока может достигать1 мкА/с м2 Ионная пушка, использующая геометрию ионизационного манометра, не может создавать ионный пучок диаметром меньше 3 мм. Для фокусировки ионного пучка к системе электродов, изображенной на рис.4.24 добавляют фокусирующие электроды или фокусирующую систему линз. После фокусирующей системы линз часто ставят отклоняющие пластины, подобные тем, что используются в электронных пушках, что позволяет производить сканирование ионным пучком области травления поверхности образца
В более совершенных ионных пушках используется высоковольтный газовый разряд. Аргон вводится непосредственно в разрядный промежуток, из которого вытягивается и формируется узкий ионный пучок с необходимой энергией. Ускоряющее напряжение ионов может достигать в таких пушках 10 кВ. Рабочий ток зависит от давления в аналитической камере
. Например, при давлении порядка 10-6 Торр ток ионного пучка может достигать 200 мкА. Преимущество ионных источников, использующих высоковольтный газовый разряд, кроме возможности получения более интенсивных ионных пучков, связано также с тем, что нет необходимости заполнять аргоном всю рабочую камеру, как это делается при использовании ионной пушки, использующей геометрию ионизационного манометра.
4.9. Поверхностная чувствительность и очистка поверхности
В методах электронной спектроскопии информацию о свойствах поверхности получают из анализа распределения электронов по энергии. Для анализа пригодны лишь те электроны, вышедшие из твердого тела, которые не потеряли энергию на своем пути в результате многократных хаотических неупругих столкновений. Такие электроны принято называть характеристическими. Схема возникновения характеристических электронов показана на рис.4.25.
 Рис.4.25. Схема возникновения характеристических электронов.
Рис.4.25. Схема возникновения характеристических электронов.
. Электроны, возбужденные на достаточно большой глубине от поверхности в результате многократных неупругих столкновений потеряют всю свою энергию и останутся в твердом теле. Часть электронов также испытавших многократные потери энергии, выйдет в вакуум с различными потерями энергии d Е и дадут вклад в бесструктурный фон в спектре вторичных электронов. Характеристическими, очевидно, будут только те электроны, которые были возбуждены на глубине, меньшей средней длины свободного пробега электронов в твердом теле l. Таким образом, глубина анализируемого слоя определяется величиной l анализируемых электронов.
Результаты экспериментов свидетельствуют (рис. 4.26), что средняя длина свободного пробега имеет минимум, расположенный вблизи 50 ¸ 100 эВ и до некоторой степени не зависит от вещества, в котором движутся электроны. В методах электронной спектроскопии анализируются электроны, энергия которых не превышает 2000 эВ. Из рис. 4.27 видно, что глубина анализируемого слоя для этих электронов не превышает 50 Å. Этим обусловлена высокая поверхностная чувствительность методов электронной спектроскопии. В ряде методов, таких, например, как спектроскопия характеристических потерь энергии электронов, глубину анализируемого поверхностного слоя можно менять, изменяя энергию первичных электронов. Таким способом можно менять глубину анализа приблизительно на порядок – от 5 до 50 Å
Существуют две причины, по которым анализ поверхности должен осуществляться в сверхвысоком вакууме. Во-первых, длина свободного пробега электронов эмитированных поверхностью исследуемого образца, должна быть намного больше размеров спектрометра, чтобы на пути к анализатору они не претерпели рассеяния и, тем самым, не были утрачены для анализа. Согласно молекулярно-кинетической теории газов средняя длина свободного пробега молекул определяется соотношением:
 Еэв
Еэв
Рис.4.26 Универсальная кривая зависимости длины свободного пробега электронов от энергии
 (4.8..)
(4.8..)
где kB – постоянная Больцмана; Т – абсолютная температура; d – диаметр молекулы; P – давление.
Оценки средней длины свободного пробега молекул азота для различных давлений приведены в таблице 4.2. Поскольку размеры измерительных камер спектрометров не превышают нескольких десятков сантиметров, то первое условие удовлетворяется уже при давлении 10-5 …10-6 Торр. Эта область давлений соответствует высокому вакууму (ВВ) и реализуется в обычных растровых или просвечивающих электронных микроскопах.
Вторая причина связана с высокой поверхностной чувствительностью методов электронной спектроскопии.
Таблица 4.2
Кинетические параметры молекул азота при различных давлениях
| Давление, Торр | Средняя длина пробега, см | Скорость поступления частиц, с-1·см-2 | Время адсорбции монослоя, с |
| 10-2 | 0,5 | 3,8 1018 | 3 10-4 |
| 10-4 | 3,8 1016 | 3 10-2 | |
| 10-5 | 3,8 1015 | 0,3 | |
| 10-7 | 5,1 104 | 3,8 1013 | |
| 10-9 | 5,1 106 | 3,8 1011 |
Поскольку большинство анализируемых электронов образуется в нескольких верхних атомных слоях, то результаты экспериментов весьма чувствительны к поверхностным загрязнениям любого рода.
Если каким либо способом получена атомарно чистая поверхность для исследования, то адсорбция остаточных газов в камере высокого вакуума будет приводить за время сравнимым с длительностью эксперимента к существенным изменениям состояния поверхности. Скорость поступления частиц на поверхность определяется соотношением:
 , (4.9)
, (4.9)
где P –давление газовой фазы у поверхности; m – масса молекулы.
Для практических расчетов формулу (5.8.2) удобно представить в ином виде, где давление выражается в миллиметрах ртутного столба, Т в Кельвинах, а масса молекулы заменяется ее молекулярной массой М:
 , (4.10)
, (4.10)
здесь скорость поступления имеет размерность молекула/(cм2×c).
Используя соотношение (4.10), можно вычислить время образования монослоя в предположении, что поверхностная плотность атомов в завершенном поверхностном слое составляет приблизительно 1015 атомов на квадратный сантиметр и все молекулы поступившие на поверхность остаются на ней (коэффициент прилипания равен единице). Полученные таким образом кинетические параметры для молекул азота (N2) при различных давлениях приведены в таблице 4.2 Поскольку реальный коэффициент прилипания молекул к поверхности значительно меньше единицы, то время образования монослоя значительно больше указанных в таблице 4.2. Для чистых полупроводников (Si, Ge, GaSb, InSb) вероятность прилипания кислорода лежит в интервале 10-2 … 10-4.
 |
сверхвысокого вакуума (СВВ). Современные вакуумные камеры из нержавеющей стали, магниторазрядные и сорбционные насосы позволяют без больших проблем создать и поддерживать необходимое время требуемые условия вакуума.Для получения достоверных сведений об элементном составе, химических связях и структуре поверхности необходимо в условиях сверхвысокого вакуума очистить исследуемую поверхность от примесных атомов. В настоящее время при очистке наибольшее распространение получили три основные способа:
Скол в сверхвысоком вакууме. Этот способ применим для получения атомарно чистой поверхности материалов, которые легко расщепляются по определенным кристаллографическим плоскостям. Например, монокристаллы германия и кремния раскалываются вдоль плоскости (111), щелочно-галлоидные монокристаллы (NaCl, KCl и др.), кристаллы PbS, PbSe, PbTe, имеющие структуру NaCl скалываются по плоскости (100). Полупроводники типа AIIIBV (InSb, InAs, GaAs, GaSb) расщепляются вдоль плоскости (110).
Устройство для многократного скалывания монокристаллического образца в сверхвысоком вакууме показано на рис.4.27. Образец в виде прямоугольного бруска с нарезками на одной из сторон, расположенных на равном расстоянии друг от друга, для облегчения процесса скалывания располагается на специальном упоре. Скалывание производится с помощью металлического клина, вдавливаемого в нарезку. Следующее скалывание производится после подачи образца в направлении, указанном на рисунке стрелкой, так, чтобы клин установился напротив очередной нарезки.
Недостатки метода получения чистой поверхности сколом в сверхвысоком вакууме связаны с ограниченным числом материалов, пригодных для этих целей. Кроме того, кристаллографическая ориентация поверхности не может быть выбрана произвольным образом. В большинстве случаев поверхность скола имеет достаточно большое количество дефектов, таких, например, как ступеньки и адатомы. Образец можно расколоть лишь ограниченное число раз, что также ограничивает применимость данного метода очистки поверхности.
Нагрев в сверхвысоком вакууме. Этот метод получения чистой поверхности связан с возрастанием скорости десорбции поверхностных атомов с увеличением температуры образца. Эффективность этого метода определяется соотношением между энергией связи адсорбата с поверхностью и энергией теплового движения поверхностных атомов. Температура (в Кельвинах), при которой происходит интенсивная десорбция примесных атомов с поверхностей металлов, может быть оценена по формуле.
 , (4.11.)
, (4.11.)
где DH – энергия связи (в ккал/моль) слоя атомов газа, адсорбированного на поверхности данного металла (теплота адсорбции).
Для большинства материалов Т меньше температуры плавления материала Тпл, что делает возможным применения для этих материалов метода термической очистки поверхности в сверхвысоком вакууме. Но для многих металлов и полупроводников Т > Тпл, и их не удается очистить нагреванием. Например, температура плавления германия 1210 К, а теплота адсорбции для GeO и GeO2 составляет соответственно 122 и 129 ккал/моль. Способ термической очистки используется главным образом для тугоплавких металлов, таких как W, Mo и др.
Применение температурной очистки поверхности полупроводниковых материалов неэффективно, так как атомы углерода, составляющие основную долю примесных атомов на поверхности образует с материалом подложки соединения с очень сильной связью. Для удаления окисла с поверхности кремния, например, необходим нагрев образца до 1170 К, однако уже при температуре 1070 К на поверхности кремния образуются его соединения с углеродом, удалить которые значительно труднее, чем соединения кремния с кислородом. Для очистки поверхности монокристаллического кремния разработаны методы, сочетающие предварительную химическую обработку на воздухе с последующим нагревом образца в сверхвысоком вакууме. Как правило, очистка проводится в три этапа:
1. Влажная химическая обработка для удаления углерода с поверхности подложки.
2. Создание пассивирующего слоя окиси на поверхности кремния.
3. Термическое удаление окиси кремния с поверхности в сверхвысоком вакууме.
В результате проведения обработки в такой последовательности, температура, при которой происходит полная очистка поверхности кремния от атомов примеси, снижается до 980 К
Наиболее универсальным методом очистки поверхности является бомбардировка ионами инертных газов (ионное травление ). На практике обычно для этих целей применяют ионы аргона. Ионы с энергией 0,5 … 5 кэВ, формируемые ионной пушкой, взаимодействуя с поверхностью твердого тела, распыляют поверхностные атомы, как материала образца, так и примесей. Поэтому метод ионной очистки эффективен, даже если скорость удаления частиц примеси намного меньше, чем атомов материала.
Поскольку с помощью ионной бомбардировки можно за сравнительно короткое время удалить большое число атомных слоев, он может быть использован для послойного анализа элементного состава приповерхностных слоев. В этом случае после каждого цикла ионного травления записывается спектр оже-электронов, по которому рассчитываются атомные концентрации элементов на соответствующем расстоянии от поверхности. Подробнее физические основы послойного анализа в электронной спектроскопии обсуждаются в следующем разделе.
Недостатком метода ионного травления является сильное повреждение поверхности. Восстановить структуру поверхности в ряде случаев удается последующим термическим отжигом образца в сверхвысоком вакууме.
4.10. Анализ энергии в электронной спектроскопии и разрешающей способности энергоанализаторов
Центральной частью любого спектрометра является энергоанализатор – устройство, позволяющее измерять число электронов, обладающих энергиями, лежащими в заданном интервале. В энергоанализаторах используются физические принципы, связанные с отклонением заряженных частиц в электростатическом или магнитном поле.
Наибольшее распространение в электронных спектрометрах получил энергоанализатор типа цилиндрическое зеркало (АЦЗ). Анализатор этого типа состоит из двух коаксиальных полых металлических цилиндров (рис.4.28.). Во внутреннем цилиндре A имеются узкие прорези S1 и S2 для прохождения входящих и выходящих электронов соответственно. К внешнему цилиндру B прикладывается отрицательный по отношению к внутреннему цилиндру потенциал Vab. В пространстве между цилиндрами электростатическое поле изменяется обратно пропорционально радиусу r:
 4. 12)
4. 12)

Рис.4.28. Схма анализатора типа цилиндрического зеркала здесь ra и rb – соответственно радиусы внутреннего и внешнего цилиндров.
Электроны, влетевшие в энергоанализатор от источника О с некоторой скоростью v0 под углом влета θ, в результате отклонения от первоначальной траектории под действием электрического поля, будут двигаться по криволинейной траектории и сфокусируются на выходе в точке О1, в которой располагается коллектор электронов, например, электронный умножитель.
Наилучшая фокусировка электронного пучка в АЦЗ достигается при угле влета электронов q = 42° 18,5'. В этом случае расстояние между точками О и О1, т.е. между образцом и детектором электронов L0 = 6,12 ra. Максимальное удаление электронов от оси анализатора rmax»0,3 L0.
Важнейшей характеристикой энергоанализатора является его разрешающая способность R. В случае бесконечно узких входной и выходной щелей через энергоанализатор проходят лишь электроны со строго определенной энергией Е0. При конечной ширине щелей S1 и S2 АЦЗ будет пропускать электроны с угловым разбросом ±Dq и энергетическим разбросом D Е. Две группы электронов равной интенсивности с некоторой средней энергией Е считаются разрешенными, если при их наложении результирующая кривая имеет минимум. Минимальное энергетическое расстояние между этими группами электронов D Еmin при данном значении Е и определяет разрешающую способность анализатора:
 . (4.13)
. (4.13)
Уменьшить D Еmin можно уменьшением ширины щелей, однако при этом уменьшается чувствительность прибора, так как уменьшается доля электронов, достигающих детектора электронов. Пропускная способность анализатора, показывающая какая часть общего потока электронов, испускаемого источником, доходит до детектора, характеризуется светосилой энергоанализатора. Светосила определяется произведением площади сбора электронов на функцию пропускания энергоанализатора. Улучшить разрешающую способность анализатора без уменьшения его светосилы можно уменьшением энергии электронов Е, влетающих в анализатор. С этой целью перед входной щелью анализатора ставят замедляющие электроны сетки или систему электронных линз.
Величина, обратная разрешающей способности анализатора, r = 1/R называется относительным разрешением анализатора. Энергетическое расстояние D Еmin в формуле (4.13) часто называют абсолютным разрешением энергоанализатора. Для АЦЗ r = 0,15…0,5%.

Рис.4.29. Двухпролетный анализатор типа цилиндрическое зеркало
Промышленные анализаторы, совмещающие высокую светосилу с достаточно хорошим разрешением, конструируют на базе двухпролетного АЦЗ, согласованным со сферическими сетками, осуществляющими предварительное торможение электронов (рис. 4.29). Двухпролетный анализатор, как это видно из рисунка, представляет собой два последовательных обычных АЦЗ. Для измерений с угловым разрешением используется вращающаяся диафрагма, расположенная на входе электронов во второй каскад анализатора.
Соотношение между энергией электронов Е0, регистрируемых АЦЗ, и разностью потенциалов между внешним и внутренним цилиндрами Vab определяется соотношением
 , (5.14)
, (5.14)
где е – заряд электрона.
Наибольшей светосилой и разрешением, сравнимым с АЦЗ, обладает концентрический полусферический анализатор (ПСА). В литературе его часто называют сферическим дефлектором. Анализатор этого типа состоит из двух сферических секторов с радиусами кривизны ra и rb (рис. 4.30).
 |
сферического конденсатора.
Рис.4.30. Схема концентрического полусферического энергоанализатора ( ПСА)

где Vab – разность потенциалов между внешней и внутренней сферами.
Радиус основной траектории электронов
 ( 4.16 )
( 4.16 )
В режиме фокусировки источник, находящийся в точке О и его изображение, которое расположено в точке О1, лежат на одной линии, проходящей через центр сфер. Отсюда секторный угол j не может превышать p. Зависимость между энергией электрона и приложенной разностью потенциалов определяется соотношением
 (4.17)
(4.17)
Энергетическое разрешение ПСА
 ,
,  , (4.18)
, (4.18)
здесь S1 – радиус входной апертуры, S2 – радиус выходной апертуры, Dq - максимальное угловое отклонение траектории электронов от основной траектории.
Рассмотренные выше энергоанализаторы позволяют регистрировать электроны, обладающие энергиями, лежащими в заданном «окне». В энергоанализаторах этого типа электроны пропускаются через диспергирующее электростатическое поле и их отклонение от первоначальной траектории является функцией электрического поля, приложенного к электродам анализатора. Анализаторы, работающие на этом принципе называются дисперсионными. В электронной спектроскопии широкое применение находит также энергоанализатор с задерживающим полем (АЗП) В этом энергоанализаторе используется тормозящее электростатическое поле, которое пропускает на коллектор только те электроны, кинетическая энергия которых превышает энергию задерживающего электрического поля.
Образец располагается в центре концентрических сферических сеток. Первая сетка находится под тем же потенциалом, что и образец, что гарантирует распространение электронов, покидающих образец, в направлении анализатора в свободном от поля пространстве. На вторую сетку подается отрицательный по отношению к образцу потенциал Us. Изменяя значение Us, можно регулировать долю электронов, достигших коллектора анализатора. Зависимость тока коллектора IK от энергии задерживающего поля еUs называется кривой задержки вторичных электронов. При энергиях задерживающего поля, соответствующих возбуждению в образце определенных групп электронов, например, оже-электронов, ток коллектора резко уменьшается, что приводит к появлению на реальной кривой задержки небольших особенностей.
Ток коллектора связан с интегральной кривой распределения вторичных электронов по энергии N (E) следующим соотношением:
 (4.19)
(4.19)
где ES = eUS, ЕР – энергия первичных электронов.
Как видно из соотношения (4.19), для получения зависимости N (E) необходимо продифференцировать кривую задержки вторичных электронов. Повторное дифференцирование кривой задержки позволяет освободиться от достаточно большого бесструктурного фона вторичных электронов и трансформировать особенности кривой задержки в «двойные пики». Для оже-электронной спектроскопии, например, принято представлять результаты в виде дифференциальных спектров dN (E)/ dE. Дифференцирование кривой задержки можно осуществить численными методами с использованием ЭВМ, что широко практикуется в современных комплексах для исследования поверхности. В энергоанализаторах с задерживающим полем часто применяют метод электрического дифференцирования кривой задержки.
Энергоанализатор с задерживающим полем обладает наименьшим разрешением в сравнении со сферическим дефлектором и анализатором типа цилиндрическое зеркало. Различное энергетическое разрешение рассмотренных выше анализаторов иллюстрирует рис.4.31, на котором представлены дифференциальные LMM оже-пики поверхности хрома. Все спектры были записаны при идентичных условиях. АЗП вследствие значительного аппаратурного уширения спектральных линий невозможно разделить пики хрома и кислорода, присутствие которого на поверхности металла демонстрирует спектр, полученный с помощью АЦЗ. Ширина оже-пиков в этом случае составляет приблизительно 3 эВ. Сферический дефлектор дает возможность выявления тонкой структуры спектра вторичных электронов, поскольку энергетическое разрешение для спектра, представленного на рис. 4.31 составляет ~0,1 эВ.

Рис. 4.31 Оже спектры хрома, полученные с использованием различныхэнергоанализаторов.
В электронных спектрометрах, использующих энергоанализаторы с задерживающим полем, обычно применяют метод электрического дифференцирования кривой задержки вторичных электронов, основанный на модуляции задерживающего потенциала. Повторное (двойное) дифференцирование кривой IK (US) позволяет детектировать оже-пики в виде дифференциального спектра dN (E)/ dE, т.е. в том виде, который принят в электронной оже-спектроскопии.
Для электрического дифференцирования на задерживающую сетку вместе с постоянным потенциалом US подается небольшое по амплитуде (обычно 0,1 … 5 В) переменное синусоидальное напряжение. В этом случае суммарный потенциал на сетке энергоанализатора будет равен
 , (4.20)
, (4.20)
где D U – амплитуда синусоидального напряжения, w - его частота
4.11. Современные электронные спектрометры.
В современных спектрометрах имеется возможность перемещения образца в пространстве. Конструкции многопозиционных манипуляторов, применяемых в настоящее время в вакуумной технике, позволяют перемещать образец в трех взаимно-перпендикулярных направле ниях, вращать образец, менять угол наклона плоскости образца. В ряде случаев манипуляторы снабжены системой нагревания и охлаждения образца, контроля его температуры, что позволяет производить температурные исследования.
В зависимости от назначения спектрометра в вакуумной аналитической камере располагаются один или несколько анализаторов вторичных электронов. Для электронной оже-спектроскопии, как указывалось выше, вполне подходит по своим техническим параметрам, энергоанализатор типа цилиндрическое зеркало или, в ряде случаев, анализатор с задерживающим полем. Для рентгеновской фотоэлектронной спектроскопии и спектроскопии характеристических потерь энергии высокого разрешения станавливается полусферический энергоанализатор
Дата добавления: 2015-07-10; просмотров: 263 | Нарушение авторских прав