
|
Читайте также: |
При Δ = (2k + 1) 90°, уравнение (4.4) превращается в уравнение эллипса, приведенного к главным осям
 (3.7)
(3.7)
Если амплитуды составляющих Ех и Еуравны, эллипс (3.7) превращается в окружность.Для всех остальных значений сдвига фаз Δ полуоси эллипса колебаний не совпадают с главными направлениями х и у; а отношение меньшей и большей полуосей эллипса колебаний зависит от величины сдвига фаз. При изменении от 0 до 90° это отношение изменяется от нуля до максимального значения. Эллиптически-поляризованный свет образуется в результате прохождения линейно-поляризованного света через плоско-параллельные пластинки из двояко-преломляющих кристаллов, например кварца или исландского шпата, вырезанные параллельно или под углом к оптической оси (но не перпендикулярно). Кроме того, эллиптически-поляризованный свет образуется при отражении линейно-поляризованного света от металлов и полупроводников, если угол падения φ ≠ 0, а также при полном внутреннем отражении. В случае прохождения света через анизотропные среды осями х и у, т. е. составляющими, образующими эллиптически-поляризованный свет, служат составляющие электрического вектора, лежащие в главной плоскости ей перпендикулярной. При отражении света осями х и у являются составляющие электрического вектора, лежащие в плоскости падения и в перпендикулярной ей плоскости, т. е. р- и s-компоненты.
В большинстве задач по анализу эллиптически-поляризованного света достаточно измерить сдвиг фаз Δ и отношение амплитуд  . Величину самих амплитуд. Ех и Еузнать не обязательно. В некоторых случаях определяют лишь сдвиг фаз Δ, например в минералогии при исследовании двоякопреломляющих веществ.
. Величину самих амплитуд. Ех и Еузнать не обязательно. В некоторых случаях определяют лишь сдвиг фаз Δ, например в минералогии при исследовании двоякопреломляющих веществ.

 Необходимо отметить, что часто эллиптически-поляризованный свет характеризуют отношением полуосей эллипса колебаний
Необходимо отметить, что часто эллиптически-поляризованный свет характеризуют отношением полуосей эллипса колебаний  и углом η, который составляет большая полуось эллипса с осью у (рис. 4.7). При этом связь между этими параметрами определяется следующими соотношениями
и углом η, который составляет большая полуось эллипса с осью у (рис. 4.7). При этом связь между этими параметрами определяется следующими соотношениями
 (3.8)
(3.8)
где  .
.
Таким образом, все экспериментальные методы исследования, эл-липтически-поляризованного света можно разделить на две группы; методы, основанные на измерении сдвига фаз и отношений амплитуд, и методы, основанные на измерении отношения полуосей эллипса колебаний и угла поворота полуосей эллипса относительно главных осей х и у.
3.3.2 Эллипсометрия - как метод исследования качества полированной поверхности деталей
Эллипсометрия (отражательная поляриметрия) – это оптический метод измерения, основанный на анализе изменения поляризации пучка поляризованного света при его отражений от исследуемой поверхности. Используется высокая чувствительность состояния поляризации света к свойствам и параметрам поверхности и поверхностных областей исследуемой отражающей системы при наклонном падении лучей.
Специфика технологии изготовления оптических деталей требует применения бесконтактных неразрушающих методов контроля, исключающих загрязнение и повреждение структуры поверхности деталей. Указанным требованиям удовлетворяет эллипсометрический метод как один из самых точных и чувствительных методов контроля. Для прозрачных диэлектриков наличие инородного слоя на отражающей поверхности образца приводит к изменению эллипсометрических параметров по сравнению с параметрами идеальной поверхности.
При отражении монохроматического плоскополяризованного света, падающего под углом  электромагнитная волна, взаимодействуя с веществом, обычно преобразуется в эллиптически поляризованную. Это объясняется тем, что электромагнитные колебания, совершающиеся в плоскости падения (р -колебания) светового луча и в перпендикулярной к ней плоскости (s -колебания), при отражении света по-разному изменяют амплитуду напряженности электрического поля Е и начальную фазу
электромагнитная волна, взаимодействуя с веществом, обычно преобразуется в эллиптически поляризованную. Это объясняется тем, что электромагнитные колебания, совершающиеся в плоскости падения (р -колебания) светового луча и в перпендикулярной к ней плоскости (s -колебания), при отражении света по-разному изменяют амплитуду напряженности электрического поля Е и начальную фазу  колебаний (рис.3.9). Параметрами Е и
колебаний (рис.3.9). Параметрами Е и  характеризуются т. наз. комплексные амплитуды для р- и s -колебаний падающей
характеризуются т. наз. комплексные амплитуды для р- и s -колебаний падающей 
 и отраженной
и отраженной  волн. Отношения амплитуд
волн. Отношения амплитуд  или комплексные коэффициенты отражения, можно вычислить в рамках конкретной модели отражающей поверхности, используя математический аппарат теории комплексных чисел и электромагнитную теорию света.
или комплексные коэффициенты отражения, можно вычислить в рамках конкретной модели отражающей поверхности, используя математический аппарат теории комплексных чисел и электромагнитную теорию света.
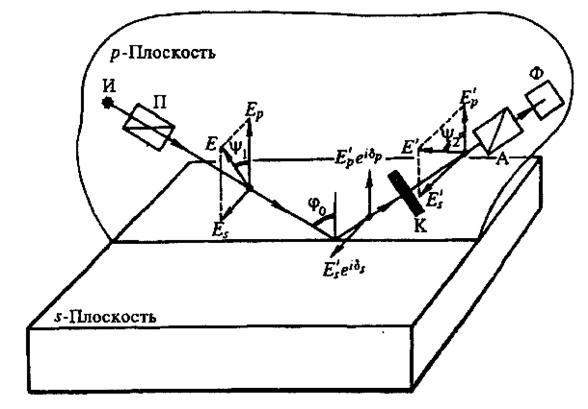
Рис.3.9 Схема действия эллипсометра;(пояснения в тексте)
Такой подход, называется прямой задачей эллипсометрии, позволяет записать основное уравнение эллипсометрии:

где  - соотв. для падающей и отраженной волн) и
- соотв. для падающей и отраженной волн) и  - эллипсометрические углы, измеряемые с помощью специальных приборов - эллипсометров.
- эллипсометрические углы, измеряемые с помощью специальных приборов - эллипсометров.
В простейшей схеме эллипсометра, приведенной на рис.3.10., монохроматический свет от источника света, проходя через призму-поляризатор, преобразуется в плоскополяризованный свет.

Рис. 3.10 – Схема эллипсометрической установки
При отражении от исследуемой поверхности между р- и s -колеба-ниями возникает разность фаз  при этом конец вектора напряженности, характеризующего результирующее электрическое колебание, описывает эллипс. Компенсатор К приводит разность фаз между р- и s -колебаниями к нулю и снова преобразует свет в плоскополяризованный, который можно полностью погасить анализатором. Гашение фиксируется фотоприемником. Значения азимутов поляризатора и анализатора в положении гашения связаны с углами ψ и Δ
при этом конец вектора напряженности, характеризующего результирующее электрическое колебание, описывает эллипс. Компенсатор К приводит разность фаз между р- и s -колебаниями к нулю и снова преобразует свет в плоскополяризованный, который можно полностью погасить анализатором. Гашение фиксируется фотоприемником. Значения азимутов поляризатора и анализатора в положении гашения связаны с углами ψ и Δ
Сами по себе величины tgψ и cosΔ не позволяют судить о наличии или отсутствии нарушенного поверхностного слоя – для этого необходимо выполнить громоздкие вычисления. Однако, если функции cosΔ и tgψ поверхности хорошо известны, любые искажения их, наблюдаемые экспериментально, без каких бы то  ни было вычислений, являются указанием на существование нарушенного поверхностного слоя. В ряде работ показано, что угловые зависимости поляризованного света при отражении оказываются достаточно чувствительными к механической обработке прозрачных стекол.
ни было вычислений, являются указанием на существование нарушенного поверхностного слоя. В ряде работ показано, что угловые зависимости поляризованного света при отражении оказываются достаточно чувствительными к механической обработке прозрачных стекол.
При отражении электромагнитной волны от произвольной отражающей системы между компонентами электрического вектора, перпендикулярной и параллельной плоскости падения, возникает разность фаз Δ, которая в общем случае приводит к эллиптической поляризации этой волны. Коэффициенты отражения системы Rр и Rs и разность фаз Δ связаны между собой сновным уравнением эллилсометрии: 
Углы ψ, Δ называют эллипсометрическими параметрами системы.
Существуют различные варианты оптических схем эллипсометров, а также различные способы проведения эллипсометрических измерений.
Обязательным условием экспериментальных методов определения эллипсометрических параметров является измерение на выходе эллипсометра интенсивности светового пучка.
По способу регистрации светового сигнала на выходе прибора, соответствующего моменту измерения, различают два основных класса эллипсометров: нулевые и фотометрические.
 В нуль-эллипсометрах, исторически появившихся первьми, поляризованные углы измеряются с помощью специальных оптических элементов-поляризаторов и фазосдвигаюших устройств (компенсаторов) – при достижении на выходе прибора нулевой (минимальной) интенсивности отраженного света. Эллипсометрические изменения нулевым способом состоят из следующих основных операций: с помощью вращения двух (из 3-х, установленных на лимбах) оптических элементов (поляризатора, анализатора и компенсатора) вокруг оптической оси гасят отраженный свет на выходе прибора, при этом третий элемент находится в фиксированном положении, обычно с азимутом 45°; отсчитывают по лимбам азимуты вращаемых элементов в положении гашения отражающего луча и из измеренных по лимбам углов рассчитывают параметры ψ и Δ, что позволяет достичь наибольшей точности измерений.
В нуль-эллипсометрах, исторически появившихся первьми, поляризованные углы измеряются с помощью специальных оптических элементов-поляризаторов и фазосдвигаюших устройств (компенсаторов) – при достижении на выходе прибора нулевой (минимальной) интенсивности отраженного света. Эллипсометрические изменения нулевым способом состоят из следующих основных операций: с помощью вращения двух (из 3-х, установленных на лимбах) оптических элементов (поляризатора, анализатора и компенсатора) вокруг оптической оси гасят отраженный свет на выходе прибора, при этом третий элемент находится в фиксированном положении, обычно с азимутом 45°; отсчитывают по лимбам азимуты вращаемых элементов в положении гашения отражающего луча и из измеренных по лимбам углов рассчитывают параметры ψ и Δ, что позволяет достичь наибольшей точности измерений.
При использовании схемы с фиксированным компенсатором, установленным после образца, вращением поляризатора добиваются получения после отражения такой ориентации эллипса поляризации света в пространстве, при которой его главные оси совпали бы с характеристическимиосями четвертьволновой фазовой пластины. В этом случае после прохождения компенсатора свет вновь становится линейно-поляризованным, так как четвертьволновая пластина добавляет к разности фаз (90°), которая имеется в эллиптически-поляризованном луче между компонентами,параллельными главным осям эллипса, дополнительную разность фаз ±90°, обращая общий фазовый сдвиг в 0 или 180°.
Для определения момента гашения луча анализатором может быть использована как визуальная, так и фотоэлектрическая регистрация на постоянном или переменном сигнале.
В качестве источников излучения в эллипсометрах обычно используется ртутные лампы (зеленая линия излучения λ = 546,1 нм), лампы накаливания с фильтрами, лазеры с фиксированной или перестраиваемой частотой, а также монохроматоры в эллипсометрах, работающих в узком спектральном диапазоне. Известно также использование λ = 435 нм.
Эллипсометрические способы контроля качества шлифования деталей реализуются в них следующим образом: повышение чувствительности способа достигается тщательной очисткой поверхности от остатков абразива и шлама в поверхностной пленке кремнезема, а повышение производительности способа контроля достигается путем экспрессного определения качества полирования поверхностей оптических деталей. Способ заключается в выполнении следующих операций: предварительно на столик эллипсометра устанавливают эталонную деталь и определяют угол падения и азимут поляризатора, при котором отраженное излучение будет поляризовано по кругу. Это достигается при равенстве интенсивностей J0 = J45 = J90, что соответствует достижению главного угла падения (Δ = 90°) и главного азимута поляризатора (ψп = ψ). Такую операцию производят однократно для образцов определенного материала. Затем, устанавливая контролируемый образец на столик эллипсометра, выставляют угол падения света и азимут поляризации поляризатора и анализатора в соответствии с определенными значениями углов для эталона и измеряют соответствующие интенсивности света.
Равенство J0 = J45 = J90 отраженного от контролируемого образца поляризованного света позволяет заключить, что качество полирования соответствует эталону, так как отраженный свет будет эллиптически поляризован, пока его главный угол и эллиптичность не станут равными главному углу и эллиптичности эталонного образца.
Определение круговой поляризации может быть осуществлено либо по равенству интенсивностей J0 = J45 = J90, анализатором, вращающимся с постоянной угловой частотой.
По величине отклонения состояния поляризации отраженного поляризованного света от круговой поляризации судят о качестве полирования контролируемого образца.
В этом случае точность определения эллипсометрических параметров соответствует δψ = 0,0005 и δΔ =0,002.
Многие методики контроля качества обработки поверхности оптических стекол основываются на модели однородного слоя и отклонение его показателя преломления от показателя преломления в объеме служат мерой отклонения реальной поверхности от идеальной.
В случае прозрачных диэлектриков наиболее полной характеристикой нарушений является распределение показателя преломления по глубине нарушенного слоя.
Учитывая, что общая глубина нарушенного слоя в случае оптических стекол порядка 20 мкм, а глубина области формирования отраженной волны порядка половины ее длины, то приходится учесть, что отраженная электромагнитная волна несет информацию об изменении показателя преломления на глубинах только до 0,5 мкм. Эти изменения могут быть невелики. Таким образом, при определении параметров нарушенного слоя, обуславливающего поляризационные характеристики отраженного излучения, можно в первом приближении воспользоваться теорией однородного слоя. Отражение света в этом случае описывается основным уравнением эллипсометрии.
Для контроля качества полирования деталей из оптических материалов можно использовать методику, в которой характеристиками качества полировки выступаем минимальная эллиптичность tg ψ и разность между утлом Брюстера вещества и главным углом контролируемой детали Δφ, характер изменения которых аналогичен изменению n и d. Контроль процессов полировки позволяет выбрать технологию обработки, приводящую к уменьшению толщины нарушенного слоя.
Методика цеховых испытаний может быть построена на сравнении tg ψ и Δφ с эталоном.
Слабая корреляция эллипсометрических характеристик с глубиной полировки и соответствующее изменения толщины и показателя преломления поверхностного слоя могут быть обусловлены особенностями поведения химически неустойчивого стекла, к которым относится стекло БК-10, в процессе механической обработки.
Предполагается, что в этом случае наблюдается преобладающее влияние полировки на свойства стекла в приповерхностной области. Химическое взаимодействие полирующей суспензии с материалом изменяет его свойства вблизи поверхности и это изменение оказывается более существенным, чем то, которое наведено предшествующей шлифовкой, т.е. химические изменения оказываются больше, чем те, которые вызваны растрескиванием материала. Полировка в этом случае не вскрывает действия трещиноватого слоя на параметры отраженного света и эти параметры не будут изменяться в процессе полировки, т.к. процесс формирования полировочного слоя и его устранения идут одновременно. По результатам исследований (таблица 3.2) можно заключить, что чем больше отличается показатель преломления полирующего вещества от значения показателя преломления в объеме материала, тем выше отклонения эффективного показателя преломления поверхностного слоя от его объемного значения.
Таблица 3.2
– Максимальное значение отклонения показателя преломления поверхностного слоя nс от объемного значения nо
| Полирующий абразив | Показатель преломления вещества | Величина отклонения 
| |
| Кварцевое стекло | Стекло К8 | ||
| Алмаз | 2,4 | 2,9 – 3,6 | 1,3 – 1,5 |
| Полирит | 1,8 – 2,0 | 1,6 – 1,9 | 0,8 – 1,0 |
| Электрокорунд | 1,76 | 1,2 – 1,7 | 0,4 – 0,6 |
| Кварцевый, порошок | 1,45 | 0,2 – 0,25 | |
| Порошок с СеО2 | 1,648 | 0,8 – 1,1 |
3.4. Методы измерения параметров пленочных структур методом эллипсометрии
Для поиска оптимальных технологических условий нанесения пленок, обработки поверхности монокристаллов и т. п. необходимо иметь удобные, надежные и высокоточные бесконтактные и неразрушающие методы контроля технологических процессов на разных его этапах, а также параметров полученных структур (пленок, активных слоев и тому подобное).
Для определения параметров строения вещества, в частности параметров пленок на его поверхности, самыми перспективными являются методы отражательной спектроэллипсометрии, поскольку отраженная световая волна формируется в тонкой приповерхностной области. Существуют эллипсометрические приборы, которые предназначены для измерения поляризационных характеристик отраженной волны, чаще всего на одной фиксированной длине. Однако не существует универсального метода, который позволил бы по измеренным значениям поляризационных характеристик определить, в частности, оптические постоянные и толщину пленки. Выбор метода зависит от исследуемого объекта.
Измеряемыми величинами в эллипсометрии являются поляризационные характеристики (эллипсометрические параметры) световой волны, которые определяют форму эллипса колебаний электрического вектора световой волны.
Эллипсометрическими параметрами (эллипсометрическими углами) называют разность фаз Δ между компонентой E s электрического вектора, перпендикулярной плоскости падения световой волны, и компонентой E p, параллельной этой плоскости, и tg ψ, значение котоpого равно отношению коэффициентов отражения в р - и s-плоскостях.
Наиболее пригодным для эллипсометрических измерений является фотометрический эллипсометр, который, в отличие от существующих компенсационных эллипсометров, не нуждается в компенсаторе, имеет меньшее время измерения. Это создает возможность измерения на волнах
 |
 |
 (3.4.1)
(3.4.1)
 (3.4.2)
(3.4.2)
Схема такого прибора приведена на рис.3.11.
 |
Поляризационное устройство 2 (призма Глана с воздушным промежутком) придает световой волне линейную поляризацию. Оно помещено в оправу, снабженную устройством поворота 3 поляризатора вокруг направления распространения светового пучка и измерения азимута y, и механизмом юстировки 4 поляризатора.
Блок анализатора поляризации отраженной световой волны также содержит призму Глана 5, устройство поворота 6 и механизм юстировки 7 поляризатора.
Гониометр представляет собой механизм измерения угла падения с угловыми делениями до 0,5минуты с двумя плечами, на которых монтируются блоки поляризатора и анализатора, источник света, коллимационная система. На оси гониометра устанавливается столик Зр с платформой для образца, снабженный механизмом поворота образца в вертикальной и горизонтальной плоскостях, а также механизмом поступательного перемещения платформы перпендикулярно ее поверхности.
Механизм изменения угла падения имеет две штанги одинаковой длины (АС и ВС), закрепленные одним концом в точках А и В на плечах гониометра на одинаковых расстояниях от его центра. Вторым концом штанги прикреплены к муфте С, которая может свободно перемещаться вдоль штанги ЗрС, установленной по биссектрисе угла между плечами. Конец Зр жестко прикреплен к столику для образца, а конец С—свободный.
На плечах гониометра устанавливается система ограничительных диафрагм D1,..., D4, образующая коллиматор светового пучка.
Приемник световой энергии содержит электронный усилитель со стабилизированным источником питания. Спектральная чувствительность приемного элемента соответствует спектру излучения примененного источника света.
С целью повышения точности определения эллипсометрических параметров авторы некоторым образом усовершенствовали метод Битти. В частности, предлагается последовательно устанавливать азимуты анализатора у = 0, 45, -45 и 90°, а также эквивалентные им азимуты y +180°, измерить соответствующие интенсивности, усреднить их значения и вычислить эллипсометрические параметры по (1) и (2). Значение cosΔ определяют также по формуле
 , (3.4.3)
, (3.4.3)
а разность фаз Δ находят как среднее арифметическое от найденных из выражений (3.4.2) и (3.4.3).
При исследовании и контроле поверхностной структуры эллипсометрические параметры следует измерять вблизи главного угла падения (при котором, по определению, cosΔ=0), где они наиболее чувствительны к особенностям строения отражательной системы. Поиск главного угла удобно выполнять с помощью параллелограммного механизма, который позволяет изменять угол падения вращением плеча с источником света, оставляя при этом неизменным ход отраженного луча. При различных значениях угла падения измеряют интенсивности I45 и I-45, пока не выполнится условие I 45= I– 4 5,
согласно (3.4.3).
3.4.1.Связь эллипсометрических параметров с параметрами системы
Воснове работы предлагаемого прибора лежит теория взаимодействия электромагнитной волны с веществом. Эллипсометрические параметры связаны с параметрами отражающей системы через основное уравнение эллипсометрии
 (3.4.4)
(3.4.4)
где Δ =δp– δs; tg, ψ =׀Rp/Rs׀
Rp и Rs - коэффициенты отражения системы в p- и s–плоскостях образца;
i -мнимая единица.
Комплексные коэффициенты отражения Rp и Rs определяются строением отражающей системы и являются функциями оптических постоянных сред, из которых она состоит, толщины слоев, угла падения и длины волны света, геометрии границы раздела и т. п.
Благодаря тому, что отраженная световая волна формируется в тонком приповерхностном слое исследуемого вещества, отражательный эллипсометрический метод имеет высокую чувствительность к особенностям строения и параметрам вещества в области формирования отраженной волны.
Эллипсометрический прибор контроля, построенный по усовершенствованной схеме метода Битти «поляризатор—образец—анализатор», может использоваться при исследованиях диэлектрических и полупроводниковых объектов. Для увеличения точности в таком приборе, в отличие от классического, поляризатор должен быть установлен под углом, меньшим 45°. Измерения должны выполняться при оптимальном угле падения и максимальном наборе азимутов анализатора 0, 45, 90, -45° и диаметрально противоположных им.
Достоинства эллипсометрии: простота и быстрота измерений (имеются автоматические эллипсометры), возможность производить их в ходе процесса в вакууме, при высоких температурах, в агрессивных средах; кроме того, при экспериментах поверхностисти не загрязняются и не разрушаются. Недостаток метода -трудность правильного выбора модели отражающей системы и интерпретации результатов измерений. Поэтому наиболее перспективно сочетание эллипсометрия с другими методами исследования поверхности, например, с оже-спектроскопией, УФ и рентгеновской спектроскопией. методами дифракции электронов и рассеяния ионов.
На рис.3.12 приведен эллипсометр ES-2. Спектральный диапазон измерений 270-1050 нм. Диапазон изменения углов падения – 45-90 градусов. Время измерения спектров эллиптических параметров ψ и Δ – 20 сек. Точность определения ψ и Δ по воспроизводимости 0.003 и 0. 005 градусов, а показателя преломления и толщины пленок 0.001 и 0.01, соответственно. Долговременная стабильность 0.01 градуса. Диаметр пучка 3 и 0.2 мм (с микроприставкой).

Рис. 3.12 Универсальный сканирующий спектроэллипсометр ES-2
3.5 Чистота оптической поверхности
Окончательный контроль чистоты оптических поверхностей; осуществляется в соответствии с ГОСТ 11141-84 только для полированных поверхностей, параметр шероховатости которых Rz не более 0,100 мкм.
Регламентируются поперечные и продольные размеры дефектов, их суммарная длина и число, а также скопления дефектов. Класс 0 – 10, например допускает на полированной поверхности наличие царапин, ширина которых не превышает 0,002 мм, и точкидиаметром не более 0,004 мм. Размер световой зоны с таким требованиями обычно составляете 1/3 полного светового диаметра поверхности.
Контроль оптических поверхностей классов чистоты 0-10, 0-5 и 0-40 производят визуально при помощи оптического прибора, увеличение которого соответствует тому, при котором деталь рассматривается в приборе, но не менее 6х. Если такое указание отсутствует, то контроль производят при помощи микроскопа с увеличением 25х (например, МИР-2) для класса 0-10; лупы с увеличением 10-12х – для класса 0-20 и лупы 6х – для класса 0-40.
Контроль деталей с поверхностями I – III классов чистоты производят также с помощью лупы 6х, поверхности более грубых классов контролируются невооруженным глазом. Поскольку степень видимости царапины зависит от направления падающего свет (вдоль или поперек царапины), то деталь во время контроля вращают. Поверхность рассматривают на фоне черного экрана (обычно черный бархат) при освещении лампой накаливания мощностью от 50 до:100 Вт. Колба лампы должна быть прозрачной. Оптимальный угол падения лучей 45°. Размеры царапин и точек оценивают визуально (сравнивают с наборами образцов царапин точек).
Образцовые царапины и точки измеряют на микроскопе тип УИМ в косо направленных пучках света на темном фоне. В сомнительных случаях размеры царапин и точек проверяют с помощью микроскопа с окуляром-микрометром, освещая поверхность конденсором темного поля. В приложении 3 к ГОСТ 11141-84* приведен конкретный пример расчета для контроля чистоты поверхности по скоплению дефектов.
3.6 Лучевая прочность
3.6.1 Лучевая прочность оптической среды и покрытий оптических элементов
Лучевая прочность- способность среды или элемента силовой оптики сопротивляться необратимому изменению оптических параметров и сохранять свою целостность при воздействии мощного оптического излучения (напр., излучения лазера). Лучевая прочность при многократном воздействии часто называется лучевой стойкостью. Лучевая прочность определяет верхнее значение предела работоспособности элемента силовой оптики. Понятие лучевая прочность возникло одновременно с появлением мощных твердотельных лазеров, фокусировка излучения которых в объём или на поверхность среды приводила к её оптическому пробою. Лучеваяпрочность численно характеризуется порогом разрушения (порогом пробоя) q х - плотностью потока оптического излучения, начиная с которой в объёме вещества или на его поверхности наступают необратимые изменения в результате выделения энергии за счёт линейного (остаточного) или нелинейного поглощения светового потока, обусловленного многофотонным поглощением, ударной ионизацией или возникновением тепловой неустойчивости. Первые два механизма реализуются в прозрачных средах, лишённых любого вида поглощающих неоднородностей, а также при микронных размерах фокальных пятен или предельно малых длительностях импульсов излучения. При этом лучевая прочность достигает очень больших значений ~1010-1013 Вт/см2. При значительных размерах облучаемой области оптический пробой обусловлен тепловой неустойчивостью среды, содержащей линейно или нелинейно поглощающие неоднородности (ПН) субмикронных размеров. Рост поглощения в окружающей микронеоднородность матрице связан с её нагревом ПН. При этом в материалах с малой шириной запрещённой зоны увеличивается концентрация свободных электронов, а в широкозонных диэлектриках происходит термическое разложение вещества. Распространяющаяся по веществу волна поглощения, инициированная неоднородностью, приводит к быстрому росту размеров поглощающего дефекта до критической величины, при которой образуются макроскопические трещины. Тепловая неустойчивость в реальных оптических средах в широких световых пучках возникает при энергетической освещённости в пределах 106-107 Вт/см2 для импульсов длительностью больше 10-5 с. С уменьшением длительности импульса лучевая прочность возрастает вследствие нестационарности нагрева неоднородностей. Лучевая прочность(ЛП) резко увеличивается при уменьшении размеров облучаемой области из-за уменьшения вероятности попадания ПН в световой пучок (рис.3.13). При диаметрах светового пятна больше 1 мм ЛП обычно выходит на постоянный уровень. В любых режимах воздействия лазерного излучения на среду ЛП зависит от энергии связи ширины запрещённой зоны кристаллов и степени связности полимерного каркаса стёкол. Порог разрушения среды с температурной зависимостью коэффициента поглощения вида  определяется по формуле
определяется по формуле
Дата добавления: 2015-07-10; просмотров: 344 | Нарушение авторских прав