
Свойства. Кремний - элемент 4-й группы, связь между атомами ковалентная, тип кристаллической решетки - алмаз.
В настоящее время кремний играет основную роль в производстве полупроводниковых приборов, это объясняется следующими факторами:
1. Достаточная ширина запрещенной зоны, которая обеспечивает хороший диапазон рабочих температур материала от -60 до +1300С.
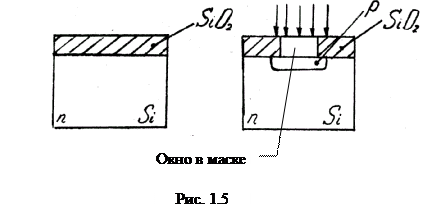 2. Cобственный SiO2 обладает хорошими защитными и маскирующими свойствами, что используется в современной технологии производства полупроводниковых приборов по планарно-эпитаксиальной технологии. Она вся основана на маскирующих свойствах SiO2 (рис.1.5).
2. Cобственный SiO2 обладает хорошими защитными и маскирующими свойствами, что используется в современной технологии производства полупроводниковых приборов по планарно-эпитаксиальной технологии. Она вся основана на маскирующих свойствах SiO2 (рис.1.5).
Через окно в маске nз SiO2 проводят диффузию атомов B. Маскирующие свойства связаны с тем, что коэффициент диффузии примеси в SiO2 много меньше, чем у кремния.
3. Оптимальная температура плавления: 1420 °С. Она позволяет использовать в качестве контейнерного материала плавленый кварц. Более высокая температура создала бы проблемы с материалом для тиглей и реакторов, при более низкой температуре стало бы невозможным проведение процесса диффузии, протекающего с достаточной скоростью при температуре 1100 – 12000С.
4. Доступность сырья. Содержание кремния в земной коре составляет около 28 %.
Недостатки кремния: он не обладает излучательными свойствами и поэтому не пригоден для изготовления ОКГ и светодиодов; недостаточно высокая подвижность электронов, что препятствует созданию на нем СВЧ приборов: непрямой переход запрещенной зоны.
Получение. Для получения поликристаллического кремния Si используется кремнезём. Из кремнезёма восстанавливают кремний в электрических печах с помощью углеродосодержащих материалов. При этом получают технический кремний - спёк с содержанием примесей до 1 %. Из него сначала восстанавливают легкие летучие соединения тетрахлорид, трихлорсилан кремния, моносилан кремния, по реакции восстановления:
Si +2Cl2 ® SiCl4
Si +3HCl ® SiHCl3 +H2
Для получения моносилана сначала изготовляют кремниево-магниевый сплав и моносилан извлекают последующей реакцией:
MgS14 + 4NH4 Cl ® SiH4 + 2MgCl2 +4NH3
Полученные соединения подвергают затем глубокой очистке методом ректификации. SiH4-газ и его ректификацию проводят после сжижения и при tкипения= 143° К. Из чистых соединений восстанавливают кремний по реакции восстановления из галосоидных соединений – хлорсиланов (тетрахлоридов кремния или трихлорсилана).
SiCl4 +2H2 «Si+4HCl
SiHCl2 +H2 «Si+3HCl
Термическое разложение гибридов (моносилана)
SiH4 «Si+2H2 (пиролиз)
Поскольку кремний можно очистить практически от всех примесей, кроме бора, коэффициент распределения которого близок к единице, то принято условно оценивать чистоту получаемого кремния по содержанию в нем бора или соответствующему этому содержанию удельному сопротивлению. Первым методом получают кремний с удельным сопротивлением до 102 Ом×см, определяемым частотой по бору, однако кроме бора полученный этим методом кремний может содержать заметные количества углерода и кислорода. Второй метод позволяет получить более чистый кремний с удельным сопротивлением ~103 Ом×см.
Восстановление идет на нагретые кремниевые прутки, через которые пропускают ток. На них оседает кремний и получается поликристаллический материал. Диаметр прутков с поликристаллическим кремнием может от 8 до100 мм. Полученный поликристаллический кремний используется в производстве монокристаллического кремния. Наиболее распространенный – метод Чохральского (метод вытягивания из расплава), схематическое изображение процесса приведено на рис. 1.6.
Процесс идет в атмосфере инертного газа, или в вакууме. Монокристаллическая затравка, вырезанная в нужном кристаллографическом направлении, опускается в поликристаллический кремний. После оплавления и появления 1-й порции кремния затравку начинают поднимать вверх, тянущийся за ней столбик кремния постепенно затвердевает. Структура наращенного слоя повторяет структуру подложки. После выращивания небольшого столбика кремния его диаметр регулируют скоростью подъема V. Связь скорости подъема V и диаметра кристалла dV= const.
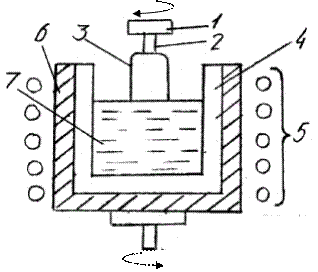 1 – держатель затравки.
1 – держатель затравки.
2 – монокристалическая затравка.
3 – слиток монокристалического Si.
4 – кварцевый контейнер.
5 – ВЧ индуктор или нагреватель.
6 – графитовая оболочка.
7 – расплав поликристалического Si.
|
Основная задача при выращивании монокристалла – получение чистого кремния с минимальным содержанием дефектов, из которых наиболее распространенным являются дислокации. К другим видам дефектов относятся неконтролируемые примеси, которые могут попадать в кремний при плавке. Высокая активность кремния в расплавленном состоянии приводит к тому, что при использовании в качестве материала тигля высокочистого синтетического кварца он является источником кислорода, переходящего в расплав. Другой неконтролируемой примесью, которая может присутствовать в кремнии, является углерод; источник его – нагретые части установки, изготовленные из графита. Наличие углерода и кислорода приводит к появлению в выращенных кристаллах различного рода включений. Дефекты любого вида являются крайне нежелательными для кремния, ибо они в итоге определяют выход годных изготавливаемых изделий и их надежность.
В производство полупроводниковых приборов идет ~ 50% cлитка. Остальная часть используется для вторичной переработки. Наличие примесей кислорода приводит к тому, что кислород связывает примеси меди и серебра, т.к. эти примеси диффундируют в сторону высокой концентрации кислорода. Недостаток примесей меди и серебра изменяет время жизни зарядов в полупроводнике. Избавиться от кислорода невозможно. Получают кремний с минимальным содержанием кислорода и большим значением времени жизни неосновных зарядов методом безтигельной зонной плавки. Обычно его применяют при выращивании кремния на основе моносилана. Схематичное изображение процесса показано на рис. 1.7.
К достоинствам метода можно отнести получение более чистого слитка с большим диапазоном удельных сопротивлений как р -, так и n - типа: большее время жизни неосновных носителей заряда (100…3000 мкс по сравнению с 10…50 мкс, получаемыми в монокристаллах, выращенных по методу Чохральского); недостатками являются меньшая производительность, сложная и дорогостоящая аппаратура и более высокая стоимость.

1 – держатель.
2 – слиток поликремния.
3 – индуктор.
4 – монокристал.
5 – затравка.
6 – держатель.
7 – зона расплава.
|
Сравнительная характеристика бездислокационных кристаллов, полученных методами Чохральского и бестигельной зонной плавки, приведена в табл.2.
Таблица 2
| Параметры кремния | Метод Чохральского | Зонная плавка |
| Качество кристаллов | Без дислокаций | Без дислокаций |
| Диаметр, мм | До 150 | До 100 |
| Диапазон удельных сопротивлений, Ом×см p- n- | 0,005…50 0,005…50 | 0,1…3000 0,1…800 |
| Ориентация | [111], [110], [100] | [111], [100], [511] |
| Время жизни, мкс | 10…50 | 100…3000 |
| Содержание кислорода, см-3 | 1016…1018 | 1016 |
| Содержание углерода, см-3 | 1017 | -«- |
Средний диаметр слитков, получаемых по методу Чохральского – 75 мм (могут быть и до 150 мм), а методом бестигельной зонной плавки – 60 мм (макс. 100 мм). Выращенные слитки должны удовлетворять следующим требованиям: отклонение диаметра слитка от номинала – до 2,5 мм; плотность дислокаций – менее 10 см-2; однородность свойств на уровне ±10%; отсутствие на поверхности слитка внешних дефектов (трещин, сколов и т.д.) размером более 1,5…3 мм.
В интегральной технике широко используются эпитаксиальные слои кремния. Эпитаксия – ориентированный рост слоёв и структура наращивания слоя повторяет структуру подложки. Схематическое изображение установки для эпитаксиального наращивания приведены на рис. 1.8.

1 – монокристалические подложки.
2 – графитовый держатель.
3 – индуктор.
4 – кварцевая трубка.
|
Через трубку пропускают SiCl4 насыщенный парами Н2 (очищенный через мембрану палладия).В процессе движения Si осаждается на подложках. Подложки подогревают до 1000о С. Эпитаксию кремния можно производить на сапфир- (монокристаллический Al2O3, BeO, SiO2, MgO).
Дата добавления: 2015-10-21; просмотров: 120 | Нарушение авторских прав
| <== предыдущая страница | | | следующая страница ==> |
| ПАРАМЕТРЫ ПОЛУПРОВОДНИКОВЫХ МАТЕРИАЛОВ | | | Германий |