
|
Читайте также: |
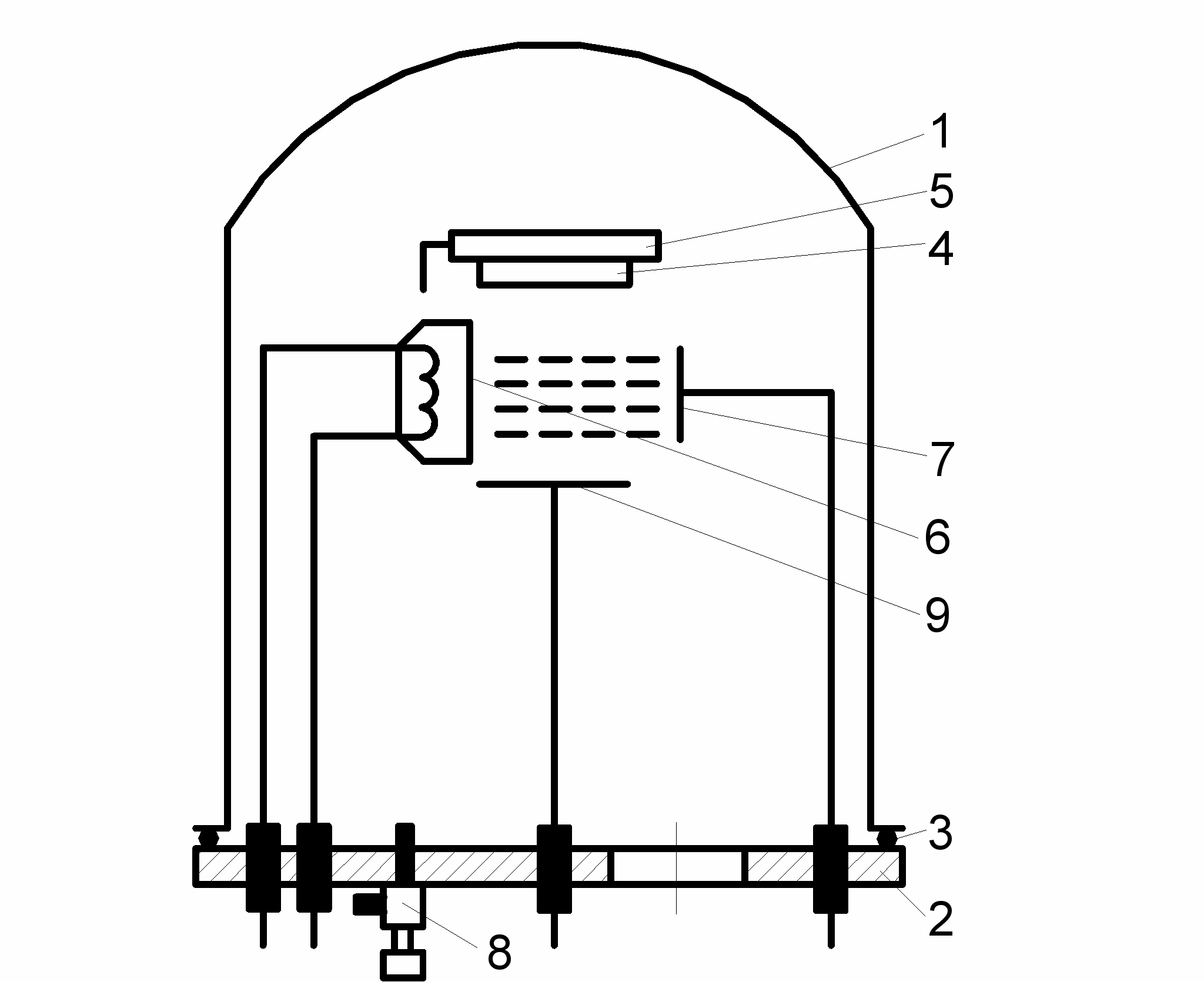 Схема установки ионно–плазменного напыления.
Схема установки ионно–плазменного напыления.
Схема этого метода показана на рис. Главная его особенность по сравнению с методом катодного напыления состоит в том, что в промежутке между электродом 9 – мишенью (с нанесенным на нее напыляемым материалом) и подложкой 4 действует независимый, «дежурный» газовый разряд. Разряд имеет место между электродами 6 и 7, причем типа разряда – несамостоятельный дуговой. Для этого типа разряда характерны: наличие специального источника электронов в виде накаливаемого катода 6, низкие рабочие напряжения (десятки вольт) и большая плотность электронно-ионной плазмы. Подколпачное пространство, как и при катодном напылении, заполнено нейтральным газом, но при более низком давлении ( мм рт. ст.).
мм рт. ст.).
Процесс напыления состоит в следующем. На мишень относительно плазмы (практически – относительно заземленного анода 7) подается отрицательный потенциал (2–3 кВ), достаточный для возникновения аномального тлеющего разряда и интенсивной бомбардировки мишени положительными ионами плазмы. Выбиваемые атомы мишени попадают на подложку и осаждаются на ней. Таким образом, принципиальных различий между процессами катодного и ионно-плазменного напыления нет. Различаются лишь конструкции установок: их называют соответственно двух– и трех–электродными.
Начало и конец процесса напыления определяются подачей и отключением напряжения на мишени. Если предусмотреть механическую заслонку (см. рис. 6.15), то ее наличие позволяет реализовать важную дополнительную возможность: если до начала напыления закрыть заслонку и подать потенциал на мишень, то будет иметь место ионная очистка мишени (см. 6.6). Такая очистка полезна для повышения качества напыляемой пленки. Аналогичную очистку можно проводить на подложке, подавая на нее (до напыления пленки) отрицательный потенциал.
При напылении диэлектрических пленок возникает затруднение, связанное с накоплением на мишени положительного заряда, препятствующего дальнейшей ионной бомбардировке. Это затруднение преодолевается путем использования так называемого высокочастотного ионно-плазменного напыления. В этом случае на мишень наряду с постоянным отрицательным напряжением подается переменное напряжение высокой частоты (около 15 МГц) с амплитудой, несколько превышающей постоянное напряжение. Тогда во время большей части периода результирующее напряжение отрицательно; при этом происходит обычный процесс распыления мишени и на ней накапливается положительный заряд. Однако во время небольшой части периода результирующее напряжение положительно; при этом мишень бомбардируется электронами из плазмы, т.е. распыления не происходит, но зато компенсируется накопленный положительный заряд  .
.
Вариант реактивного (химического) ионно-плазменного напыления открывает те же возможности получения окислов, нитридов и других соединений, что и реактивное катодное напыление (см. предыдущий раздел).
Преимущества собственно ионно–плазменного метода по сравнению с катодным состоят в большей скорости напыления и большей гибкости процесса (возможность ионной очистки, возможность отключения рабочей цепи без прерывания разряда и др.); Кроме того, на качестве пленок сказывается более высокий вакуум.
Диодная высокочастотная распылительная система содержит два электрода: заземленный анод и мишень (катод), на которую подают напряжение от ВЧ-генератора. ВЧ-распыление значительно расширяет возможности тонкопленочной технологии, позволяя получать высококачественные пленки не только металлов, сплавов и полупроводников, но и пленки диэлектриков путем распыления мишеней из диэлектрических материалов.

Рис. 3. - Форма суммарного напряжения и его составляющих на поверхности мишени:
1 – высокочастотная составляющая; 2 – напряжение, возникающее за счет ионного тока на мишень; 3 – отрицательное смещение, возникающее за счет электронного тока на мишень; 4 – суммарное напряжение на поверхности мишени
ВЧ-распыление диэлектрической мишени происходит благодаря возникновению на ней отрицательного (относительно плазмы) смещения. Механизм возникновения отрицательного смещения связан с тем, что при подаче ВЧ-напряжения на помещенную в плазму мишень на ее поверхность начинают попеременно поступать электронный и ионный токи. В первый момент после подачи ВЧ-напряжения его постоянная составляющая на поверхности диэлектрической мишени равна нулю. В этом случае электронный ток в положительный полупериод ВЧ-напряжения значительно превосходит ионный ток в отрицательный полупериод, что объясняется значительно большей подвижностью электронов по сравнению с ионами. Таким образом на поверхности мишени накапливается отрицательный заряд и, следовательно, растет отрицательное напряжение смещения до тех пор, пока средние значения электронного и ионного токов не сравняются.
Отрицательное смещение определяет энергию ионов и, следовательно, эффективность распыления мишени. Поэтому необходимо, чтобы положительный заряд на поверхности мишени, приобретенный за счет ионного тока, не был бы большим, поскольку это вызывает уменьшение отрицательного смещения. Действие положительного заряда компенсирует электронный ток на мишень, восстанавливая напряжение отрицательного смещения. Очевидно, что чем длительнее период ВЧ-колебаний, тем больший положительный заряд приобретает мишень и тем сильнее уменьшается отрицательное смещение. Для устранения этого явления период ВЧ-колебаний должен быть достаточно малым.
42. Ионно-плазменное напыление. Трех – электродная система.
При бомбардировке поверхности твердого тела отдельными атомами, ионами или молекулами, имеющими энергию, большую энергии связи атома тела, материал мишени распыляется. Если поблизости от нее поместить подложку, то часть атомов распыляемой мишени попадет на подложку и конденсируется (напыляется), образуя пленку.
Дата добавления: 2015-08-18; просмотров: 204 | Нарушение авторских прав
| <== предыдущая страница | | | следующая страница ==> |
| Электронно-лучевое напыление. | | | Установка ионно-плазменного напыления |