
Читайте также:
|
| Метод | Измеряемые величины | Описание | Особенности | +/- |
| Четырехзондовый метод | Удельное сопротивление |  Измеряем падение напряжения V23
Измеряем падение напряжения V23
| Образец правильной формы, конечность, проводимость/непроводимость основания и расположение зондов учитывается в F. | Источники ошибок: - размер образца - инжекция неосновных носителей - нагрев током - случайные изменения расстояния между зондами - поверхностный ток утечки (Guard ring) |
| Метод Ван-дер-Пау | Удельное сопротивление | 
| - однородная толщина
- односвязный образец
- малые контакты
- контакты по периметру

| |
| Послойное стравливание | Профиль сопротивления | - разрушающий метод | ||
| Измерение сопротивления растекания на косошлифованном образце | Профиль сопротивления | 
| + при малых углах распределение с точностью до нескольких атомных слоёв глубины | |
| ////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////// | ||||
| ТеромоЭДС | Тип проводимости |  Носители бегут с горячего на холодный электрод. По знаку напряжения определяем их тип
Носители бегут с горячего на холодный электрод. По знаку напряжения определяем их тип
| ||
| Выпрямление по трёхконтактному методу | Тип проводимости |  Большое переменное U подаётся на 1-2, с 4-2 снимается постоянное. «Плюс» на металле соответствует прямому току в п/п n-типа Большое переменное U подаётся на 1-2, с 4-2 снимается постоянное. «Плюс» на металле соответствует прямому току в п/п n-типа
| ||
| Эффект Холла | Концентрация легирующей примеси Теоретически можно даже энергетические уровни примеси измерять |   Зная B и j, измеряем E и получаем R, которая связана с n
Зная B и j, измеряем E и получаем R, которая связана с n
| При B→∞ Холл-фактор r→1. Это хорошо, но труднодостижимо. При малых B нужен учёт механизма рассеяния электронов (фононы, примеси)
 - Схемы для избавления от неэквипотенциальности зондов
- Lock-In или долго измерять
- Схемы для избавления от неэквипотенциальности зондов
- Lock-In или долго измерять
| |
| Метод вольтфарадных характеристик | Концентрация легирующей примеси в однородных полупроводниках Анализ энергетической структуры вблизи гетеропереходов | Измерение вольтфарадной характеристики и определение N из её наклона по формуле Численное интегрирование профиля концентрации примеси | Даёт значение N на границе ОПЗ | |
| ////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////// | ||||
| Исследование диода (ВАХ) | φ, n, Rs | 
| ||
| Исследование диода (ВАХ) | n, Rs | 
| ||
| Исследование диода (ВАХ) | Вместо I в ВАХ взять 
| Можно измерять при малых V | ||
| Определение высоты барьера диода | φ | Снятие температурной зависимости тока насыщения Is(T), получаемого из ВАХ (ВАХ+Is(T)) | Ток идёт через самый маленький барьер, 0.81 eV | n надо определить независимо |
| Определение высоты барьера диода | φ | Из точки возможного пересечения ВФХ 1/C2(V) с осью V по формуле | Максимальные вклады в ёмкость у контактов с наибольшей площадью 0.905 eV | |
| Определение высоты барьера диода | φ | По выходу фотоэмиссии: 
| Усреднённый вклад всех факторов, 0.98 eV | + наиболее точный |
| ////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////// | ||||
| Определение энергии активации и эффективного сечения рассеяния электронов на глубоком уровне | Ena, σna | График  , из наклона Ena, из отсечки по ординате σna , из наклона Ena, из отсечки по ординате σna
| Сечение захвата может зависеть от температуры Ena=Ec-Et+ΔE (+ энергия активации обратного процесса) | |
| Определение концентрации глубоких уровней и вида носителей | Nt, тип носителей | Есть формула для изменения емкости во времени, концентрацию мелких доноров определяем независимо из ВФХ, Nt можно выразить

| ||
| DLTS | Спектр глубоких уровней Сечение захвата | 

| + высокая чувствительность + чувствительность к знаку + количественный - ограниченный диапазон легирования - нужен хороший диод | |
| Эффект Пула-Френкеля | Вид потенциала притягивающего центра | 
| ||
| TSCap | Энергия термоионизации уровня | Охладили образец, подали импульс, нагреваем с разными скоростями и измеряем C(T). | + σ(T) - больше не проблема + для DLTS окна скоростей не всегда оптимальны - на 2 порядка меньше чувствительность | |
| Спектроскопия адмиттанса | Энергия ионизации уровня |  Измеряем G(T) и C(T) для разных ω и строим что-то наподобие
Измеряем G(T) и C(T) для разных ω и строим что-то наподобие

| ||
| I-DLTS, TSC | Энергия ионизации уровня | Для низкоомных образцов При росте T растёт интенсивность пиков | - большие токи утечки (при большой T) - нечувствителен к знаку носителей - нет прямого соотношения между I и Nt | |
| PICTS, TSC | Энергия ионизации уровня | Для высокоомных образцов | ||
| ////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////// | ||||
| 2 метода поверхностного фотоЭДС | Диффузионная длина | 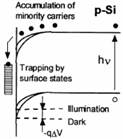
| Для ОПЗ << и ~ L | |
| 2 метода с током короткого замыкания | Диффузионная длина | Для ОПЗ << и ~ L | ||
| Pulsed MOS capacitor | Диффузионная длина | |||
| EBIC | Диффузионная длина Рекомбинационная активность (дислокации) | 

| ||
| ////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////// | ||||
| EDX и WDX X-ray спектроскопия | Рентгеновский спектр | |||
| EXAFS | Край поглощения, геометрия окружения | |||
| XANES | Край поглощения, валентность окружения | |||
| µ-XRS | Спектр рентгеновской люминесценции, наличие элементов | |||
| µ-XAS | Рентгеновское поглощение, валентность (=XANES) | |||
| ////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////// | ||||
| SIMS | Химический состав | 
| Возможные артефакты: - перекрытие масс - влияние краев кратера 3 вида SIMS: - статический (обнаружение < ML) - динамический (профилирование) - картирование | + высока чувствительность - разрушающий - нет точной теории ионного испарения - разные матрицы имеют различные (до 6и порядков) коэффициенты испарения |
| Обратное Резерфордовское рассеяние | Химический состав | 
| - каналирование | + не деструктивный + чувствителен к монослоям - чувствительность к объемным материалам хуже - разрешение по глубине ~100А для плёнок <2000A - чувствительность к разным элементам разная |
| Нейтронно-активационный анализ | Химический состав | 
| - глиняные горшки - можно обнаружить золото в монокристаллическом кремнии | + чувствительный - чувствительность к легким элементам слабая - нельзя профилировать |
| ////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////////// | ||||
| X-ray топография | Дефекты | 
| + карты больших образцов + комплексный анализ + не нужно подготавливать образец - нет увеличения - долгие времена - очень дорогой | |
| TEM | Микроскопия, дефекты | 
| - conventional - HR-TEM - STEM Z-контраст | + очень высокое разрешение + комплексный анализ - дорогой - разрушающий - подготовка образца - HR – численное моделирование результата необходимо |
| STM | Микроскопия, работа выхода, плотность состояний |  Работа выхода определяется из графика
Работа выхода определяется из графика
| - значение работы выхода получается меньше, чем при измерениях в глубоком вакууме - качество острия 2 моды: - постоянный ток - постоянная высота зонда от поверхности | - нужен проводящий образец |
| AFM, EFM, MFM – бесконтактные Local probe electrical measurements - контактный | Микроскопия, контактная разность потенциалов, дифференциальная ёмкость | 
| - метод Кельвина для измерения контактной разности потенциалов и дифференциальной ёмкости - метод механических колебаний для определения контактной разности потенциалов |
1. Четырехзондовый метод и метод Вандер-Пау. Методы измерения удельного сопротивленияи и типа проводимости..
2. Сопротивление растекания и методы профилирования.
3. ВЧ-проводимость и схемы измерения электропроводности бесконтактными методами.
4. Определение типа проводимости по термоэдс и токов через выпрямляющие контакты.
5. Геометрии образцов для измерения эффекта Холла и способы его измерения.
6. Дифференциальная емкость диода Шоттки и p-n перехода.
7. Вольтфарадные характеристики и профилирование концентрации нескомпенсированных доноров (акцепторов).
8. Методы определения контактного и последовательное сопротивления диода.
9. Определение высоты барьера Шоттки-диода и фактора идеальности.
10. Статистика заполнения уровней в запрещенной зоне полупроводника. Вы
11. Влияние глубоких уровней на емкость диода. Нестационарная емкостная спектроскопия глубоких уровней.
12. Эффект Пула-Френкеля с локальных состояний и определения зарядового состояния глубокого центра.
13. Проявление глубоких уровней в измерениях емкости и тока диода. Термостимулированные токи и емкость.
14. Фотоиндуированная релаксационная токовая спектроскопия. Фотоидуцированная проводимость.
15. Генерационные и рекомбинационные процессы и характерные времена жизни в полупроводниках различного состава.
16. Определения диффузионной длины: из спектральной зависимости поверхностной фотоэдс или фототока диода
17. Определения диффузионной длины из измерений емкость - фототок диода
18. Токи генерации в обратно-смещенной МОП-структуре и время жизни.
19. Токи, индуцированные световым или электронным лучом и получение карт распределения рекомбинационной активности.
20. Нейтронно-активационный анализ. Принцип работы метода и чувствительность.
21. Вторично-ионная масс-спектрометрия.
22. Обратное Резерфордовское рассеянье.
23. Рентгеновские методы определения элементного состава и композиции материала.
24. Схема электронного микроскопа и возможности современной просвечивающей электронной микроскопии.
25. Рентгеновская топография.
26. Принципы работы СТМ и туннельной спектроскопии.
27. Принципы работы и операционные моды АСМ.
При ответе на основной вопрос билета о методе измерения, необходимо изложить физические основы методы, возможности и ограничения его применения. Кроме того, на экзамене могут быть заданы дополнительные вопросы, например:
Дата добавления: 2015-07-20; просмотров: 69 | Нарушение авторских прав
| <== предыдущая страница | | | следующая страница ==> |
| СВОДКА ЗАМЕЧАНИЙ И ПРЕДЛОЖЕНИЙ 1 страница | | | Пути подвоза и эвакуации |